I PCB-design og produksjon brukes vias som «broer» for å koble sammen forskjellige lag. Hvis de er eksponert, kan de lett bli en skjult fare som påvirker kvaliteten på monteringen. Under lodding kan loddpasta falle ned i hullet, noe som fører til utilstrekkelige loddforbindelser eller til og med hindrer dannelse av effektive loddforbindelser, omtrent som et gap i en demning som lekker vann. Når slike problemer oppstår, påvirker de direkte elektrisk ledningsevne og pålitelighet til kretsen.
Via covering-teknologi, i enkle termer, innebærer å pakke eller fylle viahull med en loddeleggmask eller spesielle materialer, noe som effektivt kan forhindre loddepasta fra å trenge inn og redusere risikoen for utilsiktede kortslutninger. Avhengig av funksjonelle krav og bruksområder, finnes det tre vanlige dekningsmetoder:
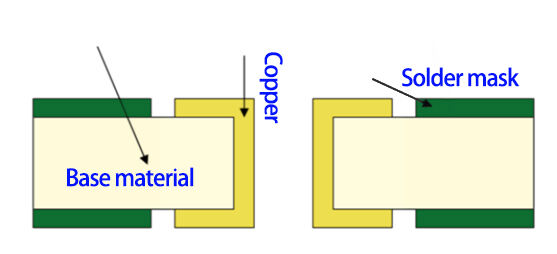
Via Tenting dekker viahullene direkte med loddeleggindeks uten ekstra prosedyresteg, omtrent som å dekke viahullene med et lag «gauze». Det finnes to spesifikke former for dette:
1. Enkeltsidig skjerming: den ene siden av viahullet er dekket med loddeleggindek, mens den andre siden er åpen, egnet for scenarier med moderate krav til varmeavledning;
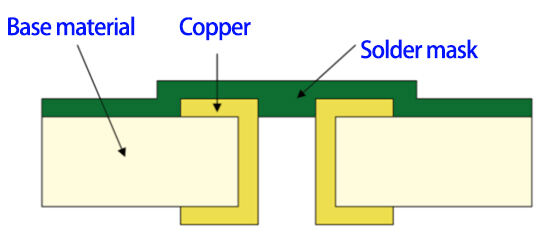
2. Dobbelsidig skjerming: begge sider av viahullet er fullstendig dekket med loddeleggindek, gir bedre beskyttelse og egnet for vanlige signalviahull, og kan effektivt forhindre at loddepasta renner inn i hullene ved en feiltagelse.
Denne metoden er billig og enkel i prosessen og er den mest brukte beskyttelsesmetoden i konvensjonelle PCB-er. Merk ved konstruksjon: Filen for åpning i loddeleggmasken må tydelig markere området som ikke skal dekkes for å unngå konflikter mellom skjermingsprosessen og konstruksjonskrav
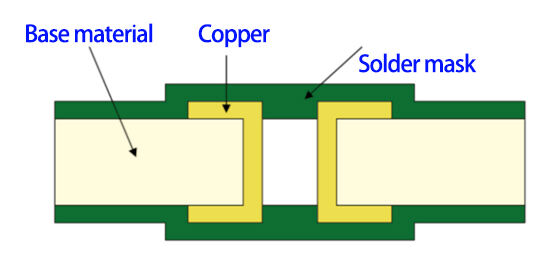
Gjennomkoblingspropp innebærer å «halv-fylle» gjennomkoblingen med ikke-ledende materialer som epoksyhar og loddeleggmel, omtrent som å proppa til gjennomkoblingen med en «myk propp». Det finnes to spesifikke metoder:
1. Ensidig propp: delvis fylling av gjennomkoblingen med ikke-ledende materiale fra den ene siden, dekke overflaten med loddelegg og la den andre siden være åpen;

2. Tosidig propp: delvis fylling av begge sider av gjennomkoblingen og dekking med loddelegg.

Via-fylling innebærer å fylle viaen helt med ikke-ledende materiale, noe som tilsvarer å legge til en «solid kjerne» i viaen. Denne prosessen er spesielt egnet for områder med høy tetthet, som BGA. Hvis viaene på disse stedene er eksponert, vil loddepasten renne fra landet inn i hullet under lodding, noe som fører til utilstrekkelige loddeforbindelser og kalde loddeforbindelser, eller til og med ingen lodding i det hele tatt, noe som har stor betydning for monteringskvaliteten på PCB. Dens hovedformer er:
1. Full fylling + valgfri dekning: fyll hele viaen med ikke-ledende materiale, og overflaten kan dekkes med loddepose (eller ikke dekkes, avhengig av loddekrav);

2. Fylling + kapping: Dette er en mer avansert prosess – først elektrolytisk belagt og rengjør viaen, press deretter i ikke-ledende materiale og fastfryss det, og til slutt slipes hullet opp til en flat overflate og metalliseres for å sikre at overflaten både er flat og loddevennlig. Denne metoden er spesielt egnet for "Via-in-Pad"-design, og kan også støtte pakking med stablede mikroviaer, og baner veien for tett forbindelse mellom BGAs.
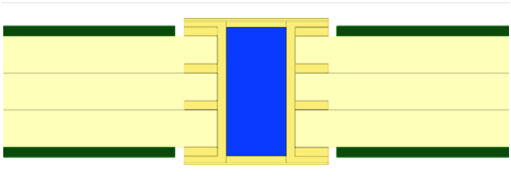
Valg av riktig via-dekning krever en helhetsvurdering basert på faktorer som via-diameter, antall PCB-lag og monteringskrav. Om det dreier seg om grunnleggende skjerming eller avansert fylling, er kjernen å redusere lodderingsrisikoene og forbedre PCB-påliteligheten. Dette er også prinsippet vi alltid følger i prosessvalget, for å sikre at hver eneste PCB kan tåle praktiske anvendelser.