Via-in-Pad är en avancerad genomborrad teknik som används i högdensitets PCB-design. Dess kärnegenskap är att integrera den metallbelagda genomborringen (PTH) direkt i komponentens lödpad, uppnå elektrisk koppling genom att avsätta ledande material såsom koppar i genomborringen och täcka hålet med lödlack för att säkerställa lödningens tillförlitlighet.
Till skillnad från traditionella genomborrade hål är traditionella PTH:er vanligtvis placerade i icke-lödareor utanför komponentpadsen och måste anslutas till padsen via ytterligare banor; medan Via-in-Pad hoppar över denna del av övergångskonstruktionen och gör att genomborrningshålet och paden kan integreras direkt. Denna design fungerar som att öppna en "direktkanal" i mitten av paden, vilket kan avsevärt förkorta signalfördröjningen och minska signalförluster. Ur ett praktiskt perspektiv är fördelarna med via-in-pad koncentrerade till två aspekter: utnyttjande av utrymme och prestandaförbättring: genom att integrera genomborrningshålet i paden kan det elektriska kretskortets yta minskas, vilket bidrar till att minska produktens storlek; samtidigt minskar den förkortade signalvägen risken för impedanssprång och förbättrar signalkvaliteten.
Denna teknik ställer dock högre krav på tillverkningsprocessen: det är nödvändigt att exakt kontrollera borrningsprecisionen (håldiametern är vanligtvis ≤0,3 mm) och elektropläteringens enhetlighet för att säkerställa en pålitlig koppling mellan kopparlagret i hålväggen och plattformen; vissa konstruktioner kräver också att hålen fylls med harpik och jämnas för att undvika bubblor eller kall lodning under svetsning. Därför är tillverkningskostnaden högre än för traditionell PTH, och används vanligtvis i scenarier med hög täthet och höga prestandakrav.
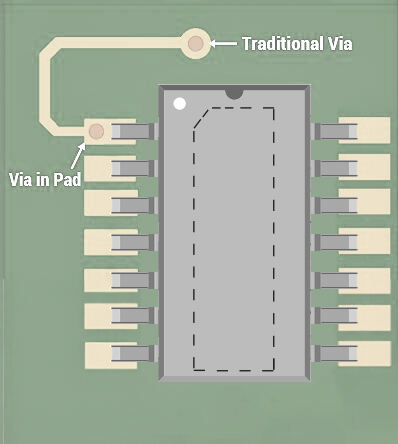
Användningen av via-in-pad måste bedömas holistiskt i kombination med tätheten i PCB:s layout och komponentkarakteristik. Följande är designrekommendationer för specifika scenarier:
Efter att ha slutfört fan-out-designen i PCB-routningens tidiga skede, om innerlager-routning kan uppnås genom konventionella viahål, finns det ingen anledning att använda via-in-pad. Tar man till exempel BGA-kapslade komponenter, kan effektiv routning uppnås genom att optimera via- och routningsparametrar när fan-out-vägen ligger i området mellan pad. De typiska designstandarderna är som följer:
Baserat på ovanstående parametrar, när BGA-stiftsavståndet är större än 0,35 mm är utrymmet mellan pad tillräckligt för att rymma konventionella viahål och routning, och fan-out kan slutföras utan att vara beroende av via-in-pad. I detta fall kan ett traditionellt design bättre balansera kostnad och processpålitlighet.
När komponentens avstånd mellan benen är för litet, vilket gör det svårt att uppnå konventionell färdigställning, blir via-in-pad ett nödvändigt val. Till exempel är avståndet mellan kontaktfläckarna i högdensitets BGA-paket smalt, och konventionella viahåll och spår kan inte placeras på grund av storleksbegränsningar. Då måste viahålen integreras direkt i kontaktfläckarna, och kanaler för inner- eller bottenlagerförbindelser öppnas genom Via-in-Pad för att undvika signalfördröjningar eller layoutfel som orsakas av trång trafik i kopplingen.
Kort sagt är via-in-pad:s kärnansättning att lösa "trång sektion i kopplingen vid högdensitetslayout". Vid konstruktion måste man först utvärdera genomförandet genom att analysera avstånd mellan benen och parametrar för färdigställning, för att därefter avgöra om detta tillvägagångssätt bör användas för att uppnå den optimala balansen mellan prestanda, kostnad och tillverkningsbarhet.
För BGA-enheter med låg antal kontaktpinnar kan konventionell färdigdesign uppfylla ledningskraven utan att vara beroende av Via-in-Pad. När dock BGA har ett stort antal pinnar kommer ett stort antal färdiggenomgångar snabbt att uppta den begränsade ledningsytan, vilket leder till trängsel i signalvägen. Då kan integrering av genomborrningarna i Via-in-Pad kombinera de ursprungligen oberoende "pads + via" till en enda enhet, vilket betydligt frigör ytan på PCB och skapar förutsättningar för högdensitetsledning.
Särskilt när BGA-kontaktpitchen minskas till under 0,3 mm finns det inte tillräckligt med utrymme mellan padder för att rymma konventionella genomborrningar och ledningar, och Via-in-Pad blir ett nyckelmedel för att överkomma flaskhalsen i ledningsdesignet. Genom att bädda in genomborrningarna inuti padder kan signalen ledas direkt till de inre eller bottenlagren för att undvika signalfördröjningar eller korsvis interferens orsakad av trångt packade ledningar på samma lager.
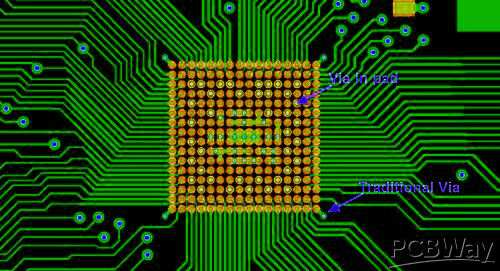
I höghastighetskretskonstruktion placeras filterkondensatorer vanligtvis nära BGA-komponenter för att undertrycka strömbrus och säkerställa signalintegritet. Om dock ett stort antal konventionella genomborrningar används inuti BGA:n kommer genomborrningsområdet på baksidan att "kämpa om utrymmet" med kondensatorpadsen, vilket gör det omöjligt att placera kondensatorn nära chipets stift.
Via-in-Pad kan helt undvika spatiala konflikter med kondensatorerna på baksidan genom att integrera genomborrningar i BGA-padsen, vilket säkerställer att filterkondensatorerna kan placeras "tätt" under eller vid kanten av BGA:n, vilket förkortar strömvägen och förbättrar filtreringseffektiviteten. Detta är avgörande för stabiliteten i högfrekventa och höghastighetskretsar.

1. Släpper slutgiltigt upp PCB-kablageutrymme: Den integrerade designen av gensthroughshål och kontaktfläckar kan minska ytutrymmets upptagande med över 30 %, vilket är särskilt lämpligt för högdensitets- och miniatyriserade konstruktioner såsom moderkort till smartphones och industriella styrenheter.
2. Förbättrar värmeledning och elektrisk prestanda: För högeffektsenheter såsom processorer och effektchips kan Via-in-Pad minska termiskt motstånd, snabba upp värmeledningen till mellanlager eller kylningsskikt och undvika lokal överhettning; samtidigt kan den förkortade strömförsörjnings-/signalvägen minska parasitisk induktans och motstånd, samt minska signaldämpning och spänningsfall.
3. Förbättrar layoutflexibilitet: Löser problemet med "otillräckliga kablagekanaler" under högdensitetsförpackning, vilket gör att komplexa kretsar såsom flerkanaliga RF-moduler kan placeras med större frihet.
1. Ökad processkomplexitet: Särskilda processer såsom hålutfyllning och yttjocknadsutjämning krävs, vilket ställer högre krav på borrningsprecision och elektropläteringsjämnhet och är benäget att få defekter såsom luftbubblor i hålen och ytdäckningar.
2. Ökade tillverkningskostnader: Särskilda processer ökar PCB-kostnaderna med 15–30 %, och produktionscykeln förlängs på grund av ytterligare kvalitetsinspektioner och reparationer.