Via-in-Pad — це передова технологія отворів, що застосовується в проектуванні друкованих плат високої щільності. Її основною особливістю є інтеграція металізованого отвору (PTH) безпосередньо в контактний майданчик компонента для поверхневого монтажу. Електричне з’єднання забезпечується шляхом нанесення провідних матеріалів, таких як мідь, усередині отвору, а потім отвір покривається лаком для створення маски й ущільнення, щоб забезпечити надійність паяння.
На відміну від традиційних металізованих отворів, звичайні металізовані отвори зазвичай розташовуються в зонах, де не виконується пайка, за межами контактних майданчиків компонентів, і для їхнього з'єднання з майданчиками потрібні додаткові сліди; тим часом Via-in-Pad усуває цю перехідну структуру, дозволяючи безпосередньо інтегрувати металізований отвір і контактний майданчик. Цей дизайн нагадує відкриття "прямого каналу" в центрі контактного майданчика, що значно скорочує шлях передачі сигналу та зменшує затримки й втрати сигналу. З точки зору практичної цінності, переваги технології via-in-pad зосереджені в двох аспектах: ефективне використання простору та підвищення продуктивності: вбудування металізованого отвору в контактний майданчик дозволяє зменшити простір, необхідний для трасування на друкованій платі, що сприяє мініатюризації продукту; одночасно скорочений шлях сигналу зменшує ризик раптової зміни імпедансу та підвищує цілісність сигналу.
Однак ця технологія ставить більш високі вимоги до виробничого процесу: необхідно точно контролювати точність свердління (діаметр отвору зазвичай ≤0,3 мм) та рівномірність електропокриття для забезпечення надійного з'єднання між мідним шаром стінки отвору та контактного майданчика; деякі конструкції також вимагають заповнення отворів смолою та вирівнювання для уникнення бульбашок або холодних паяних з'єднань під час пайки. Тому вартість її виробництва вища, ніж у традиційного PTH, і зазвичай вона використовується в сценаріях із високою щільністю та вимогами до продуктивності.
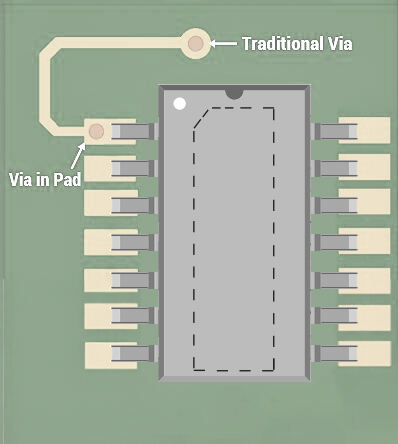
Застосування отворів у контактних майданчиках має оцінюватися комплексно в поєднанні з щільністю розташування друкованої плати та характеристиками компонентів. Нижче наведено рекомендації щодо проектування для конкретних сценаріїв:
Після завершення проектування розводки в початковому етапі маршрутизації PCB, якщо досягнення внутрішньошарової маршрутизації можливе за допомогою звичайних переходів (vias), то не має потреби використовувати via-in-pad. Наприклад, для пристроїв у корпусі BGA, коли шлях розводки розташований в центральній зоні між контактними майданчиками, ефективної маршрутизації можна досягти шляхом оптимізації параметрів переходів і трасування. Типові стандарти проектування такі:
На основі вищевказаних параметрів, коли відстань між виводами BGA більша за 0,35 мм, простір між контактними майданчиками достатній для розміщення звичайних переходів і трас, а отже, розводку можна завершити без використання via-in-pad. У цьому випадку вибір традиційного проектування краще забезпечує баланс між вартістю та надійністю технологічного процесу.
Коли відстань між виводами компонента занадто мала, щоб забезпечити традиційний розводку, використання перехідних отворів у контактних майданчиках стає необхідним вибором. Наприклад, простір між контактними майданчиками корпусів BGA високої щільності обмежений, і через розмірні обмеження не вдається розмістити традиційні отвори та траси. У цьому випадку перехідні отвори необхідно безпосередньо інтегрувати в контактні майданчики, відкриваючи канали для розводки на внутрішніх або нижніх шарах за допомогою технології Via-in-Pad, щоб уникнути затримок сигналів або відмов від надмірного ущільнення розводки.
Отже, основним призначенням технології Via-in-Pad є вирішення «вузького місця в розводці при високій щільності розташування елементів». На етапі проектування необхідно спочатку оцінити можливість її застосування за допомогою параметрів відстані між виводами та розводки, а потім вирішити, чи варто її використовувати, щоб досягти оптимального балансу між продуктивністю, вартістю та технологічністю.
Для корпусів BGA з малою кількістю виводів (low-pin-count) традиційний дизайн з відведенням (fan-out) може задовольняти вимоги трасування без використання технології Via-in-Pad. Однак, якщо кількість виводів BGA велика, значна кількість перехідних отворів швидко заповнює обмежений простір для трасування, що призводить до заторів у сигнальних шляхах. У цьому випадку інтеграція перехідних отворів безпосередньо в контактні площадки (Via-in-Pad) дозволяє об'єднати окремі "площадки + отвори" в єдине ціле, значно звільняючи місце на поверхні друкованої плати і створюючи умови для високощільного трасування.
Особливо, коли відстань між виводами BGA зменшується до менш ніж 0,3 мм, між контактними площадками залишається недостатньо місця для розміщення традиційних отворів і провідників, і технологія Via-in-Pad стає ключовим засобом подолання обмежень трасування. Вбудовуючи перехідні отвори безпосередньо в контактні площадки, сигнали можна безпосередньо направляти у внутрішні шари або на нижній шар плати, уникаючи таким чином затримок сигналів або перехресних завад, викликаних щільним трасуванням на одному шарі.
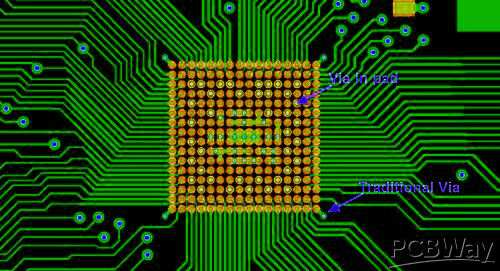
У проектуванні високошвидкісних схем фільтрувальні конденсатори зазвичай розміщують близько до корпусів BGA для придушення завад у живленні та забезпечення цілісності сигналів. Однак, якщо усередині BGA використовується велика кількість традиційних металізованих отворів, то з боку зворотного боку отвори будуть «боротися за місце» з контактними майданчиками конденсаторів, що призведе до неможливості розміщення конденсаторів близько до виводів мікросхеми.
Технологія Via-in-Pad повністю усуває просторові конфлікти з конденсаторами на зворотному боці, інтегруючи металізовані отвори безпосередньо в контактні майданчики BGA, що забезпечує можливість розміщення фільтрувальних конденсаторів безпосередньо «біля» мікросхеми, під нею або на її краях, скорочуючи шлях живлення та підвищуючи ефективність фільтрації. Це має ключове значення для стабільності високочастотних та високошвидкісних схем.

1. Остаточне звільнення простору для розводки друкованих плат: Інтегрований дизайн отворів та майданчиків може зменшити зайняту площу поверхні більш ніж на 30%, що особливо актуально для високощільних та мініатюрних конструкцій, таких як материнські плати смартфонів та модулі промислової автоматики.
2. Покращення відводу тепла та електричних характеристик: Для потужних пристроїв, таких як процесори та силові мікросхеми, технологія Via-in-Pad дозволяє знизити тепловий опір, прискорити відвід тепла до внутрішніх шарів або шарів охолодження та уникнути локального перегріву; одночасно, скорочений шлях живлення/сигналу зменшує паразитну індуктивність та опір, зменшуючи затухання сигналу та падіння напруги.
3. Підвищення гнучкості трасування: Вирішує проблему «недостатньої кількості каналів трасування» при високощільному корпусуванні, що дозволяє більш вільно проектувати складні схеми, такі як багатоканальні радіочастотні модулі.
1. Збільшення складності процесу: Потрібні спеціальні процеси, такі як заповнення отворів і вирівнювання поверхні, які вимагають вищої точності свердління та рівномірності електролітичного покриття, а також схильні до дефектів, таких як бульбашки в отворах і нерівності на поверхні.
2. Збільшення виробничих витрат: Спеціальні процеси збільшать витрати на виготовлення друкованих плат на 15%-30%, а виробничий цикл подовжиться через додаткові перевірки якості та переділи.