Via-in-Pad je pokročilá technologie vrtaných otvorů používaná v návrzích vysokohustotných plošných spojů. Jejím hlavním rysem je integrace plátovaného vrtaného otvoru (PTH) přímo do plošky povrchové součástky, elektrické spojení se dosahuje nánosem vodivých materiálů, jako je měď, do vrtaného otvoru, a otvor je poté zakrytý maskou pro zajištění spolehlivosti pájení.
Na rozdíl od tradičních vývrtů jsou tradiční PTH obvykle rozmístěny v nepájecích oblastech mimo plošky součástek a je třeba je propojit s ploškami pomocí dodatečných spojů; zatímco Via-in-Pad tento přechodový prvek vynechává a umožňuje, aby vývrt a ploška byly přímo integrovány. Tento návrh funguje jako otevření „přímého kanálu“ uprostřed plošky, což výrazně zkracuje dráhu přenosu signálu a snižuje zpoždění a ztráty signálu. Z hlediska praktické hodnoty se výhody Via-in-Pad soustředí do dvou oblastí: využití prostoru a zlepšení výkonu: vložením vývrtu přímo do plošky se snižuje potřebný prostor pro zapojení na desce plošných spojů, což napomáhá miniaturizaci produktu; zároveň zkrácená dráha signálu snižuje riziko náhlé změny impedance a zlepšuje integritu signálu.
Tato technologie však klade vyšší nároky na výrobní proces: je nutné přesně kontrolovat přesnost vrtání (průměr otvoru je obvykle ≤0,3 mm) a rovnoměrnost elektrolytického pokovení, aby bylo možné zajistit spolehlivé spojení mezi měděnou vrstvou stěny otvoru a připojovací ploškou; některé návrhy také vyžadují, aby byly otvory vyplněny pryskyřicí a vyrovnány, aby se předešlo vzniku bublinek nebo studených pájení během pájení. Náklady na výrobu jsou proto vyšší než u tradičních PTH a tato technologie je obvykle preferována v případech s vysokou hustotou a vysokými nároky na výkon.
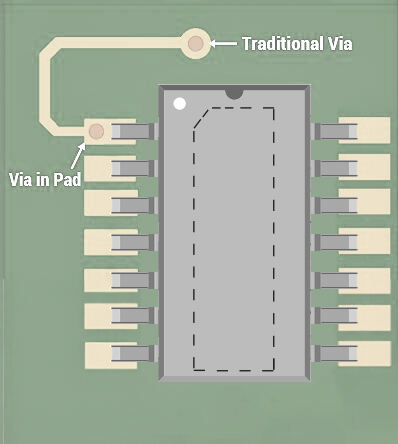
Použití Via-in-Pad musí být komplexně posuzováno ve spojení s hustotou návrhu plošného spoje a vlastnostmi součástek. Níže jsou uvedena návrhová doporučení pro konkrétní případy:
Po dokončení návrhu vějíře v rané fázi směrování PCB, pokud lze dosáhnout směrování vnitřních vrstev pomocí konvenčních přechodných děr, není nutné používat přechodné díry v plošném kontaktu. Jako příklad uveďme zařízení v BGA pouzdře: když je vějířová cesta umístěna v centrální oblasti mezi plošnými kontakty, lze dosáhnout efektivního směrování optimalizací parametrů přechodných děr a směrování. Typické návrhové standardy jsou následující:
Na základě výše uvedených parametrů, pokud je rozteč vývodů BGA větší než 0,35 mm, prostor mezi plošnými kontakty je dostatečný pro umístění konvenčních přechodných děr a směrování, a vějířový návrh lze dokončit bez nutnosti použití přechodných děr v plošném kontaktu. V tomto případě tradiční návrh lépe vyvažuje náklady a spolehlivost procesu.
Když je rozteč vývodů součástky příliš malá, což ztěžuje dosažení běžného rozvodu, stává se volba technologie vývodu v plošce (via-in-pad) nezbytnou nutností. Například prostor mezi ploškami u BGA pouzder s vysokou hustotou je úzký a kvůli omezení rozměrů nelze použít běžné vývody a spoje. V tomto případě je nutné vývody přímo integrovat do plošek a skrze technologii via-in-pad otevřít kanály pro vnitřní nebo spodní vrstvy, aby se předešlo zpoždění signálu nebo selhání uspořádání způsobeným přehuštěním spojů.
Stručně řečeno, hlavním uplatněním technologie via-in-pad je řešení tzv. "úzkého hrdla při rozvodu v hustě zaplněném prostoru". Při návrhu je nejprve nutné posoudit proveditelnost pomocí parametrů rozteče vývodů a možností rozvodu, a teprve poté rozhodnout, zda tuto technologii použít, aby bylo dosaženo optimální rovnováhy mezi výkonem, náklady a výrobními možnostmi.
U zařízení BGA s nízkým počtem vývodů může konvenční návrh fan-out splnit požadavky na zapojení bez nutnosti použití technologie Via-in-Pad. Pokud však BGA obsahuje velký počet vývodů, velké množství přechodových děr fan-out rychle zabere omezený prostor pro zapojení, což způsobí ucpání v cestě signálu. V tomto případě může integrace přechodových děr do technologie Via-in-Pad spojit původně nezávislé prvky "plošky + přechodové díry" do jednoho celku, čímž se výrazně uvolní prostor na povrchu desky plošných spojů a vzniknou podmínky pro vysokohustotní zapojení.
Obzvláště když je rozteč vývodů BGA snížena na méně než 0,3 mm, mezi ploškami již není dostatečný prostor pro umístění konvenčních přechodových děr a spojů, a proto se technologie Via-in-Pad stává klíčovým prostředkem k překonání úzkého hrdla zapojení. Vrtáním přechodových děr přímo do plošek mohou být signály přímo přivedeny do vnitřních nebo spodních vrstev, čímž se vyhne zpoždění signálu nebo vzájemnému rušení způsobenému přeplněným zapojením na téže vrstvě.
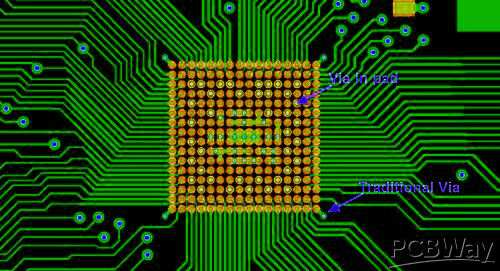
Ve vysokofrekvenčním návrhu obvodů jsou filtrační kondenzátory obvykle umístěny blízko BGA součástek, aby potlačily napájecí šum a zajistily integritu signálu. Pokud však uvnitř BGA použijete velký počet tradičních vývodů, plocha vývodů na spodní straně bude "zápasit o prostor" s ploškami kondenzátorů, což způsobí, že kondenzátor nemůže být umístěn blízko vývodům čipu.
Technologie Via-in-Pad může úplně zabránit prostorovému konfliktu s kondenzátory na spodní straně tím, že integruje vývody přímo do plošek BGA, čímž zajišťuje, že filtrační kondenzátory mohou být "těsně" umístěny pod BGA nebo na jeho okraji, zkracuje napájecí cestu a zlepšuje účinnost filtrace. To je klíčové pro stabilitu vysokofrekvenčních a vysokorychlostních obvodů.

1. Konečné uvolnění prostoru pro vodiče na desce plošných spojů: Integrovaný návrh vrtaných a pájecích plošek může snížit obsazení povrchu o více než 30 %, což je zvláště vhodné pro návrhy s vysokou hustotou a miniaturizací, jako jsou například základní desky chytrých telefonů nebo průmyslové řídicí moduly.
2. Zlepšení chlazení a elektrických vlastností: Pro výkonné součástky, jako jsou procesory a výkonové čipy, může technologie Via-in-Pad snížit tepelný odpor, urychlit přenos tepla do vnitřních nebo chladicích vrstev a zabránit místnímu přehřátí; zároveň zkrácená cesta napájení/signálu může snížit parazitní indukčnost a odpor, čímž se omezí útlum signálu a pokles napětí.
3. Zvýšení flexibility návrhu: Řeší problém "nedostatečných vodičových kanálů" u vysokohustotního pouzdření, čímž se usnadní návrh složitých obvodů, jako jsou například vícekanálové RF moduly.
1. Zvýšená složitost procesu: Vyžadují se speciální procesy, jako je vyplňování otvorů a vyrovnávání povrchu, které vyžadují vyšší přesnost vrtání a rovnoměrnost nanesení elektrolytického povlaku a náchylné jsou k vadám, jako jsou bubliny v otvorech a nerovnosti na povrchu.
2. Zvýšené výrobní náklady: Speciální procesy zvýší náklady na výrobu desek plošných spojů (PCB) o 15 % - 30 % a výrobní cyklus bude prodloužený kvůli dodatečným kontrolám kvality a předělávkám.