Via-in-Pad je pokročilá technológia vrtaných otvorov používaná v návrhoch vysoko hustých plošných spojov. Jej hlavnou vlastnosťou je integrácia vrtaného otvoru (PTH) priamo do plošky povrchovej montáže súčiastky, elektrické prepojenie sa dosiahne nanesením vodivých materiálov, ako je meď, do otvoru a otvor sa prekryje lútrom, aby sa zabezpečila spoľahlivosť spájkovania.
Na rozdiel od tradičných vývrtov sú tradičné PTH zvyčajne umiestnené v nezosváraneckých oblastiach mimo prípojné plošky súčiastok a je potrebné ich prepojiť s prípojnými ploškami pomocou ďalších spojov; zatiaľ čo Via-in-Pad tento prechodový prvok vynecháva a umožňuje priame spojenie vývrtu a prípojnej plošky. Táto konštrukcia pôsobí ako otvorenie „priameho kanála“ v strede prípojnej plošky, čo výrazne skracuje dráhu prenosu signálu a znižuje oneskorenie a straty signálu. Z hľadiska praktických výhod sú výhody Via-in-Pad sústredené do dvoch oblastí: využitie priestoru a zlepšenie výkonu: vďaka zabudovaniu vývrtu do prípojnej plošky sa znižuje priestor potrebný na prepojenie na doske plošných spojov, čo pomáha zmenšiť výsledný výrobok; zároveň skrátenie dráhy signálu znižuje riziko náhleho skoku impedancie a zlepšuje integritu signálu.
Táto technológia však kladie vyššie nároky na výrobný proces: je potrebné presne kontrolovať presnosť vŕtania (priemer otvoru je zvyčajne ≤0,3 mm) a rovnomernosť elektrolytického pokovovania, aby sa zabezpečilo spoľahlivé pripojenie medzi medenou vrstvou steny otvoru a plôškom; niektoré návrhy tiež vyžadujú, aby boli otvory vyplnené živicou a vyrovnané, aby sa zabránilo vzniku bubliniek alebo studených spájkov pri spájkovaní. Preto je jeho výrobná cena vyššia ako pri tradičnej PTH technológii a zvyčajne sa uplatňuje v prípadoch, kde sú kladené vysoké nároky na hustotu a výkon.
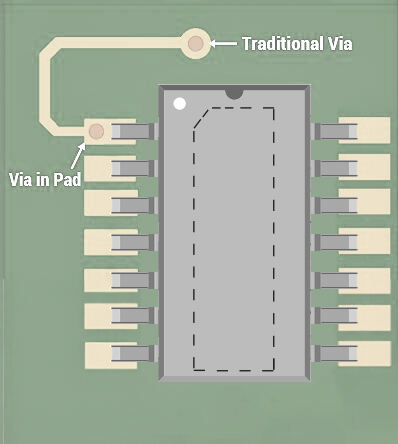
Použitie vývodov v plôšku je potrebné komplexne posúdiť v kombinácii s hustotou vývodov na doske plošných spojov a vlastnosťami súčiastok. Nižšie sú uvedené návrhové odporúčania pre konkrétne prípady:
Po dokončení návrhu výfukového systému v počiatočnej fáze trate PCB, ak je možné dosiahnuť trate v medzivrstvách pomocou konvenčných prechodov (vias), nie je potrebné používať prechody v plošných kontaktov (via-in-pad). Ako príklad uveďme zariadenia v BGA balení. Ak je trasa výfuku umiestnená v centrálnej oblasti medzi plošnými kontaktmi (pads), efektívna trasa môže byť dosiahnutá optimalizáciou parametrov prechodov a trás. Typické štandardy návrhu sú nasledovné:
Na základe vyššie uvedených parametrov, keď je vzdialenosť vývodov BGA väčšia ako 0,35 mm, priestor medzi plošnými kontaktmi je dostatočný na umiestnenie konvenčných prechodov a trás, a výfukový návrh môže byť dokončený bez použitia prechodov v plošných kontaktov (via-in-pad). V tomto prípade tradičný návrh lepšie vyvažuje náklady a spoľahlivosť výrobného procesu.
Keď je rozostup vývodov súčiastky príliš malý, čo spôsobuje potíže pri dosiahnutí bežného rozvetvenia, stáva sa sa potrebnou voľbou vrták v kontakte. Napríklad priestor medzi kontaktnými plochami vysoko integrovaných BGA puzdier je úzky a z dôvodu obmedzení veľkosti nie je možné usporiadať bežné vrtáky a spoje. V tomto prípade je potrebné vrtáky priamo integrovať do kontaktných plôch a otvoriť kanály pre vedenie na vnútorných alebo spodných vrstvách pomocou technológie vrták v kontakte, aby sa predišlo oneskoreniam signálov alebo chybám pri usporiadaní spôsobeným preťažením spojov.
Stručne povedané, hlavné využitie vrtáka v kontakte spočíva v riešení „úzkeho hrdla pri vedení spojov v podmienkach vysokohustotného usporiadania“. Pri návrhu je potrebné najprv vyhodnotiť uskutočniteľnosť pomocou rozostupu vývodov a parametrov rozvetvenia a až potom rozhodnúť, či ju zaviesť, aby sa dosiahla optimálna rovnováha medzi výkonom, nákladmi a výrobnou vhodnosťou.
Pri BGA súčiastkach s nízkym počtom vývodov môže klasický dizajn fan-out vyhovieť požiadavkám na prepojenie bez použitia výplňových viaz (Via-in-Pad). Ak však BGA súčiastka má veľký počet vývodov, veľký počet fan-out viaz rýchlo zaplní obmedzený priestor pre prepojenie, čo spôsobí preťaženie v cestách signálov. V takom prípade integrácia viaz do Via-in-Pad umožní spojiť pôvodne samostatné "plošky + via" do jedného celku, čím sa výrazne uvoľní priestor na povrchu dosky plošných spojov a vytvoria podmienky pre vysokohustotné prepojenie.
Obzvlášť keď je rozstup vývodov BGA znížený na menej ako 0,3 mm, medzi ploškami už nie je dostatok miesta na umiestnenie klasických viaz a spojov, a Via-in-Pad sa tak stáva kľúčovým prostriedkom na prekonanie úzkych miest v prepojení. Zabudovaním viaz priamo do plošiek sa signály môžu priamo smerovať do vnútorných alebo spodných vrstiev, čím sa predíde oneskoreniu signálov alebo krížovému rušeniu spôsobenému preplnenými spojmi na tej istej vrstve.
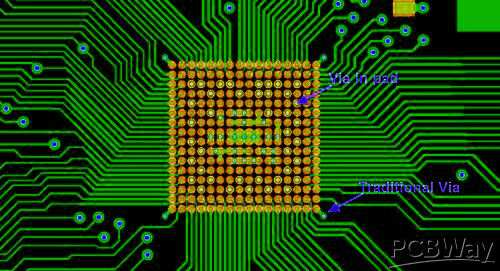
Pri návrhu vysokofrekvenčných obvodov sú filterové kondenzátory zvyčajne umiestnené v blízkosti BGA prvkov, aby sa potlačil šum napájania a zabezpečila integrita signálu. Ak však v BGA budú použité veľké množstvo konvenčných vývodov, plošiny vývodov na spodnej strane budú "zápasť o priestor" s plošinami kondenzátorov, čo spôsobí, že kondenzátory nie je možné umiestniť v blízkosti vývodov čipu.
Technológia Via-in-Pad môže úplne zabrániť priestorovému konfliktu so spodnými kondenzátormi tým, že vývody integruje priamo do plošín BGA. Tým sa zabezpečí, že filterové kondenzátory môžu byť umiestnené "tesne" pod BGA alebo na jeho okraji, čím sa skráti napájacia cesta a zvýši účinnosť filtrovania. To má zásadný vplyv na stabilitu vysokofrekvenčných a vysokorýchlostných obvodov.

1. Konečné uvoľnenie priestoru pre káblovanie dosky plošných spojov: Integrovaný dizajn vývodov a plošiek môže znížiť obsadenie povrchu o viac ako 30 %, čo je obzvlášť vhodné pre vysokohustotné a miniatúrne konštrukcie, ako sú matičné dosky smartfónov a priemyselné riadiace moduly.
2. Zlepšenie odvodu tepla a elektrických vlastností: U výkonových súčiastok, ako sú procesory a výkonové čipy, môže technológia Via-in-Pad znížiť tepelný odpor, urýchliť vedenie tepla do vnútornej alebo chladiacej vrstvy a predísť lokálnemu prehriatiu; zároveň skrátená cesta napájania/signálu môže znížiť parazitnú indukčnosť a odpor, čím sa znižuje útlm signálu a pokles napätia.
3. Zvýšenie flexibility usporiadania: Rieši problém "nedostatok kanálov pre káblovanie" pri vysokohustotnom puzdrení, čo uľahčuje usporiadanie zložitých obvodov, ako sú viac kanálové RF moduly.
1. Zvýšená zložitosť procesu: Vyžadujú sa špeciálne procesy, ako je vypĺňanie otvorov a vyrovnávanie povrchu, ktoré vyžadujú vyššiu presnosť vŕtania a rovnomernosť elektrolytického pokovovania a sú náchylné na chyby, ako sú bubliny v otvoroch a povrchové priehlbiny.
2. Zvýšené výrobné náklady: Špeciálne procesy zvýšia náklady na DPS o 15 % - 30 % a výrobná lehota sa predĺži v dôsledku dodatočných kontrol kvality a opráv.