Via-kohta levyssä on edistynyt läpäisevän reiän teknologia, jota käytetään tiheissä PCB-suunnittelussa. Sen keskeinen piirre on siinä, että se yhdistää pinnoitteen läpi menevän reiän (PTH) suoraan pintaliitännän komponentin levynpätkään, saavuttaa sähköisen yhteyden keräämällä johtavia materiaaleja, kuten kuparia reiässä, ja peittää reiän levynpätkän läpi varmistaen hitsauksen luotettavuus.
Toisin kuin perinteiset reiät, perinteiset PTH-reiät sijoitetaan yleensä komponenttipadien ulkopuolelle ei-hitsattaviin alueisiin ja niiden täytyy yhdistää padien kanssa erillisillä johdotuksilla; kun taas Via-in-Pad -tekniikassa tämä siirtorakenne voidaan jättää pois, jolloin reikä ja padi voidaan yhdistää suoraan. Tämä rakenne on kuin "suora kanava", joka avataan padin keskelle, ja joka voi huomattavasti lyhentää signaalin siirtymätä ja vähentää signaalin viivettä ja häviöitä. Käytännön arvon näkökulmasta, padin reiän etuja ovat keskittyneet kahteen näkökohtaan: tilan käytön tehostamiseen ja suorituskyvyn parantamiseen: upottamalla reikä padin sisään, PCB:n johdotustilaa voidaan säästää, mikä edistää tuotteen miniatyrisointia; samalla lyhyempi signaalipolku vähentää impedanssin äkillisen muutoksen riskiä ja parantaa signaalin eheyttä.
Tämä teknologia asettaa kuitenkin vaativampia vaatimuksia valmistusprosessille: porauksen tarkkuutta (reiän halkaisija on yleensä ≤0,3 mm) ja pinnoituksen tasaisuutta on hallittava tarkasti, jotta takataan luotettava yhteys reiän seinämän kuparikerroksen ja liitännäkkäpinnan välille; joissakin suunnitelmissa reiät on lisäksi täytettävä harmaalla ja tasattava, jotta vältetään kuplia tai kylmiä juotokseta hitsauksessa. Näin ollen sen valmistuskustannukset ovat korkeammat kuin perinteisen PTH-tekniikan kohdalla, ja sitä suositaan yleisesti tiheiden ja korkeiden suorituskykyvaatimusten skenaarioiden yhteydessä.
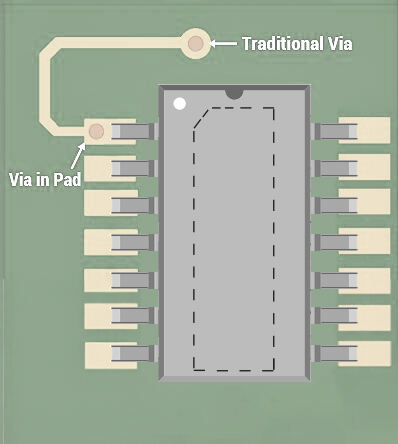
Komponenttipinnan reiäilyn soveltamista on arvioitava kokonaisvaltaisesti yhdessä PCB:n asettelutiheyden ja komponentin ominaisuuksien kanssa. Seuraavassa on suositeltuja suunnitteluratkaisuja tietyissä tilanteissa:
Kun puhdistussuunnittelu on suoritettu varhain PCB-reitityksen alkuvaiheessa, jos sisäkerroksen reititys voidaan toteuttaa käyttämällä perinteisiä viaputkia, via-in-pad-tekniikkaa ei tarvitse käyttää. Otetaan esimerkiksi BGA-pakkauksellinen laite: kun puhdistusreitti sijaitsee napojen välisellä alueella, tehokas reititys voidaan saavuttaa optimoimalla viaputkien ja reitityksen parametreja. Tyypilliset suunnittelustandardit ovat seuraavat:
Edellä olevien parametrien perusteella, kun BGA:n jalkojen väli on suurempi kuin 0,35 mm, napojen väliin jää tarpeeksi tilaa perinteisten viaputkien ja reitityksen sijoittamiseen, ja puhdistus voidaan suorittaa ilman via-in-pad-teknologiaa. Tällöin perinteisen suunnittelun valitseminen tasapainottaa paremmin kustannuksia ja prosessin luotettavuutta.
Kun komponenttipinien väli on liian pieni tavallisen johdotuksen toteuttamiseksi, viapadissa joudutaan turvautumaan välttämättömänä ratkaisuna. Esimerkiksi tiheästi sijoitettujen BGA-pakkauksen liitännösten väli on kapea, ja tavanomaisia vias- ja johdotusratoja ei voida asettaan koon rajoitusten vuoksi. Tällöin viat on integroitava suoraan liitännöksiin, ja sisäisten tai alimpien kerrosten johdotuskanavat avataan viapadin kautta, jotta vältetään signaaliviiveet tai sijoitteluvirheet, joita aiheutuu liian tiiviistä johdotuksesta.
Lyhyesti sanottuna viapadin ydinsovellus on ratkaista 'johdotuspullonkaula tiiviissä sijoittelussa'. Suunnittelussa on ensin arvioitava toteutettavuus liitännösten välin ja johdotuksen parametrien kautta, minkä jälkeen päätetään, kannattaako sitä käyttää saavuttamalla optimaalinen tasapaino suorituskyvyn, kustannusten ja valmistettavuuden välillä.
Pienellä määrällä pinnitetyillä BGA-laitteilla perinteinen säteittäissuunnittelu voi täyttää johdotusvaatimukset ilman Via-in-Pad -tekniikan käyttöä. Kun BGA:ssa on kuitenkin suuri määrä pintoja, suuri määrä säteittäisreikäjohdotuksia vie nopeasti käytettävissä olevan johdotustilan, mikä johtaa signaalityön ruuhkautumiseen. Tällöin reikäjohdotusten integrointi Via-in-Pad -tekniikalla yhdistää aiemmin toisistaan riippumattomat "liitännät + reiät" yhdeksi yksiköksi, vapauttaen huomattavasti PCB:n pinta-alaa ja mahdollistaen tiheämmän johdotuksen.
Erityisesti silloin kun BGA:n pinnityksen välimatka (pitch) pienenee alle 0,3 mm:n, ei ole tarpeeksi tilaa liitännästen välissä perinteisten reikäjohdotusten ja johdotusrajojen sijoittamiseksi, jolloin Via-in-Pad -tekniikasta tulee keskeinen keino johdotuksen pullonkaulasta selviytymiseksi. Reikäjohdotusten upottamalla liitännäisiin signaalit voidaan ohjata suoraan sisä- tai pohjakerroksille, välttäen saman kerroksen ruuhkautuneen johdotuksen aiheuttamat signaaliviiveet tai ristikkäiset häiriöt.
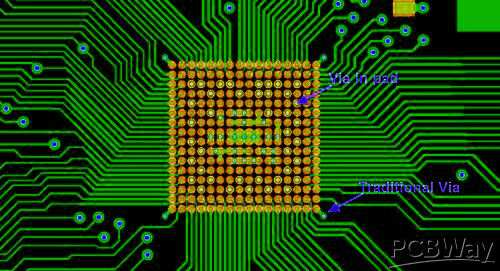
Korkean nopeuden piirien suunnittelussa suodatin kondensaattorit sijoitetaan yleensä lähelle BGA-laitteita estääkseen virran kohinaa ja varmistaakseen signaalin eheyden. Kuitenkin, jos BGA:n sisällä käytetään suurta määrää perinteisiä rei'itetyt reiät -elementtejä, BGA:n takarei'it alueella tulee "aluekiistaa" kondensaattori liitännöissä, mikä johtaa siihen, ettei kondensaattoria voida sijoittaa lähelle piirin jalkoja.
Via-in-Pad -elementti voi täysin välttää tilalliset ristiriidat takakondensaattorien kanssa integroiden reiät BGA-liitännöihin, varmistaen että suodatin kondensaattorit voidaan sijoittaa "tiiviisti" BGA:n alapuolelle tai reunaan, lyhentäen virran kuljetusreittiä ja parantaen suodatus tehokkuutta. Tämä on ratkaisevan tärkeää korkean taajuuden ja korkean nopeuden piirien stabiilisuudelle.

1. Vapauta lopulta PCB-johdotustila: Reikien ja liitospolkkujen yhdennetty suunnittelu voi vähentää pinnan tilan käyttöä yli 30 %, mikä tekee siitä erityisen sopivan korkeatiheyksisille ja miniatyyrisille suunnitelmille, kuten älypuhelin pääkorteille ja teollisuuden ohjausmoduuleille.
2. Paranna jäähdytystä ja sähköisiä ominaisuuksia: Prosessoreiden ja virtapiirien kaltaisille suuritehoisille komponenteille Via-in-Pad -rakenteella voidaan vähentää lämmönvastusta, nopeuttaa lämmön siirtymistä sisäkerrokseen tai jäähdytyskerrokseen ja estää paikallinen ylikuumeneminen; samalla lyhyempi virta/signaalipolu vähentää haitallista induktanssia ja vastusta, mikä vähentää signaalin vaimenemista ja jännitteen laskua.
3. Paranna asettelun joustavuutta: Ratkaisee korkeatiheyksisen pakkaustekniikan ongelman "riittämätön johdotustila", mikä mahdollistaa monimutkaisten piirien, kuten monikanavaisen RF-moduulin, vapaamman asettelun.
1. Lisääntynyt prosessin monimutkaisuus: Erityisprosessit, kuten reikien täyttö ja pinnan tasoitus, vaativat tarkempaa poraustarkkuutta ja sähkökupari-pinnoitteen tasaisuutta, ja ne altistavat reikäpohjan ilmakuoppaukselle ja pinnan painumisille.
2. Valmistuskustannusten lisääntyminen: Erityisprosessit nostavat PCB-levyjen kustannuksia 15–30 %, ja valmistusaika pitenee lisälaadunvalvonnan ja korjaustöiden vuoksi.