Via-in-Pad هي تقنية متقدمة للثقوب المعدنية المستخدمة في تصميم الدوائر المطبوعة ذات الكثافة العالية. تكمن ميزة هذه التقنية في دمج الثقب المعدني المغطى (PTH) مباشرة داخل الوصلة الخاصة بالمكونات السطحية، ويتم التوصيل الكهربائي من خلال ترسيب مواد موصلة مثل النحاس داخل الثقب، ويتم تغطية الثقب بطبقة من مادة عازلة لضمان موثوقية اللحام.
على عكس الثقوب التقليدية، يتم عادةً ترتيب الثقوب التقليدية من نوع PTH في مناطق غير ملحومة خارج وسادات المكونات ويجب أن تتصل بالوسادات عبر مسارات إضافية؛ بينما يُلغي تصميم Via-in-Pad هيكل الانتقال هذا، مما يسمح بدمج الثقب والوسادة مباشرة. يشبه هذا التصميم فتح "ممر مباشر" في مركز الوسادة، مما يقلل بشكل كبير من طول مسار نقل الإشارة ويحد من تأخير الإشارة وفقدانها. من حيث القيمة العملية، تتركز مزايا Via-in-Pad على جانبين رئيسيين هما استخدام المساحة وتحسين الأداء: من خلال دمج الثقب داخل الوسادة، يمكن تقليل المساحة المطلوبة للأسلاك على لوحة الدوائر المطبوعة (PCB)، مما يساعد على تصغير حجم المنتج؛ وفي الوقت نفسه، يقلل المسار الإشاري الأقصر من خطر حدوث تغير مفاجئ في المعاوقة ويحسن سلامة الإشارة.
ومع ذلك، فإن هذه التكنولوجيا تضع متطلبات أعلى على عملية التصنيع: من الضروري التحكم بدقة في دقة الحفر (عادة ما يكون قطر الثقب ≤0.3 مم) وفي تجانس الطلاء الكهربائي لضمان الاتصال الموثوق بين طبقة النحاس في جدار الثقب والوتد؛ كما تتطلب بعض التصاميم أيضًا ملء الثقوب براتنج وتسويتها لتجنب تكون فقاعات أو لحامات باردة أثناء عملية اللحام. وبالتالي، تكون تكاليف تصنيعها أعلى من تلك الخاصة بالثقوب المعدنية التقليدية (PTH)، ويتم عادة تفضيلها في السيناريوهات ذات الكثافة العالية والمتطلبات الأداء العالي.
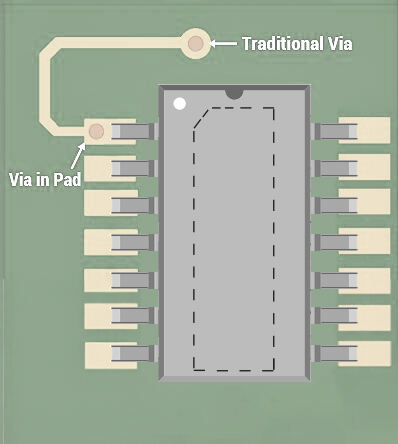
يجب تقييم تطبيق الثقوب داخل الوتد (Via-in-Pad) بشكل شامل بالاشتراك مع كثافة تخطيط الدائرة المطبوعة (PCB) وخصائص المكونات. فيما يلي عدد من التوصيات التصميمية للسيناريوهات المحددة:
بعد الانتهاء من تصميم المروحة في المرحلة المبكرة من توجيه الدوائر المطبوعة (PCB)، إذا كان بالإمكان تحقيق توجيه الطبقات الداخلية باستخدام الثقوب الانتقالية التقليدية، فلا حاجة لاستخدام تقنية الثقب الانتقالي في الوصلة (via-in-pad). وعلى سبيل المثال لا الحصر، في حالة الأجهزة المعبأة بتنسيق المصفوفة الكروية (BGA)، عندما يكون مسار التوزيع موجودًا في المنطقة المركزية بين الوصلات، يمكن تحقيق توجيه فعال من خلال تحسين معايير الثقوب الانتقالية والتوجيه. وتتمثل المعايير التصميمية النموذجية فيما يلي:
بناءً على المعاملات المذكورة أعلاه، عندما يكون تباعد أطراف المصفوفة الكروية (BGA) أكبر من 0,35 مم، تكون المساحة بين الوصلات كافية لاستيعاب الثقوب الانتقالية والتوجيه التقليدية، ويمكن إكمال عملية التوزيع دون الاعتماد على تقنية الثقب الانتقالي في الوصلة (via-in-pad). في هذه الحالة، يمكن للاختيار التصميم التقليدي تحقيق توازن أفضل بين التكلفة وموثوقية العملية.
عندما يكون تباعد دبوس المكون صغيرًا جدًا، يصبح من الصعب تحقيق مروحة خارجية تقليدية، ويصبح استخدام الفيا في الوصلة (Via-in-Pad) خيارًا ضروريًا. على سبيل المثال، يكون المسافة بين الوصلات في الحزم ذات الكثافة العالية (BGA) ضيقة، ولا يمكن ترتيب الفياس والمسارات التقليدية بسبب قيود الحجم. في هذه الحالة، يجب دمج الفياس مباشرة داخل الوصلات، وفتح قنوات التوصيل في الطبقة الداخلية أو السفلية من خلال تقنية الفيا في الوصلة (Via-in-Pad) لتجنب تأخير الإشارة أو فشل التخطيط الناتج عن ازدحام الأسلاك.
باختصار، إن التطبيق الأساسي لتقنية الفيا في الوصلة (Via-in-Pad) هو حل 'ازدحام التوصيلات تحت تخطيط كثيف'. وعند التصميم، من الضروري أولاً تقييم الجدوى من خلال تباعد الدبابيس وعوامل المروحة الخارجية (Fan-out)، ثم اتخاذ قرار بشأن استخدام هذه التقنية لتحقيق أفضل توازن بين الأداء والتكلفة وقابلية التصنيع.
بالنسبة لأجهزة BGA ذات عدد الدبوس المنخفض، يمكن أن تفي تصميمات المروحة الخارجية التقليدية بمتطلبات التوصيل دون الحاجة إلى استخدام Via-in-Pad. ومع ذلك، عندما تكون أعداد دبابيس BGA كبيرة، فإن عددًا كبيرًا من الثقوب الانتقالية للمروحة الخارجية ستأخذ بسرعة المساحة المحدودة للتوصيل، مما يؤدي إلى ازدحام في مسارات الإشارة. في هذه الحالة، يمكن أن يساهم دمج الثقوب الانتقالية داخل Via-in-Pad في دمج ما كان في الأصل "أقطاب + ثقوب انتقالية" منفصلة في وحدة واحدة، مما يحرر بشكل كبير مساحة سطح اللوحة المطبوعة ويخلق الظروف الملائمة للتوصيل عالي الكثافة.
وبشكل خاص عندما يقل تباعد دبابيس BGA عن 0.3 مم، لا توجد مساحة كافية بين الأقطاب لاستيعاب الثقوب والمسارات الانتقالية التقليدية، ويصبح استخدام Via-in-Pad وسيلة رئيسية للتغلب على الاختناق في التوصيل. من خلال دمج الثقوب الانتقالية داخل الأقطاب، يمكن توجيه الإشارة مباشرة إلى الطبقات الداخلية أو السفلية لتجنب تأخير الإشارة أو التداخل المتبادل الناتج عن التوصيل المزدحم على نفس الطبقة.
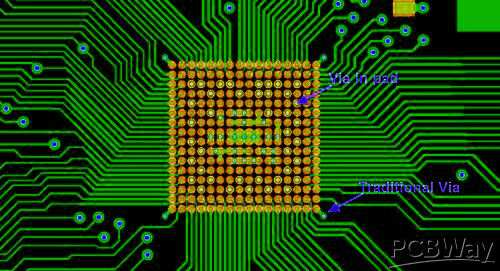
عند تصميم الدوائر عالية السرعة، يتم عادةً وضع المكثفات الفلترية بالقرب من أجهزة BGA لقمع ضوضاء الطاقة وضمان سلامة الإشارة. ولكن، إذا تم استخدام عدد كبير من الثقوب التقليدية داخل منطقة BGA، فإن مساحة الثقوب على الجانب الخلفي ستكون في "منافسة على المساحة" مع وصلات المكثف، مما يؤدي إلى عدم القدرة على وضع المكثف بالقرب من دبابيس الشريحة.
يمكن لتقنية Via-in-Pad تجنب التعارضات المكانية مع المكثفات الخلفية بشكل كامل من خلال دمج الثقوب داخل وصلات BGA، مما يضمن إمكانية وضع المكثفات الفلترية "بشكل وثيق" أسفل وصلات BGA أو على الحافة، وتقصير مسار الطاقة وتحسين كفاءة الترشيح. وهذا أمر بالغ الأهمية لاستقرار الدوائر ذات التردد العالي والسرعة العالية.

1. الإفراج النهائي عن مساحة توصيل اللوحة: التصميم المتكامل للثقوب والنقاط يقلل من مساحة السطح المستخدمة بنسبة تزيد عن 30٪، وهو مناسب بشكل خاص للتصاميم ذات الكثافة العالية والحجم الصغير مثل لوحات الهواتف الذكية ووحدات التحكم الصناعية.
2. تعزيز التبريد والأداء الكهربائي: بالنسبة للأجهزة عالية القدرة مثل المعالجات والشرائح الكهربائية، يمكن لتكنولوجيا الثقوب في النقاط تقليل مقاومة الحرارة، وتسريع نقل الحرارة إلى الطبقة الداخلية أو طبقة التبريد، وتجنب ارتفاع درجة الحرارة المحلية؛ وفي الوقت نفسه، يمكن تقصير مسار الطاقة/الإشارة تقليل الحث والمقاومة الطفيلية، وتقليل تلاشي الإشارة وانخفاض الجهد.
3. تحسين مرونة التخطيط: حل مشكلة "عدم كفاية قنوات التوصيل" تحت التغليف عالي الكثافة، مما يجعل تخطيط الدوائر المعقدة مثل وحدات RF متعددة القنوات أكثر سهولة.
١. زيادة في تعقيد العملية: هناك حاجة إلى عمليات خاصة مثل ملء الثقوب وتسوية السطح، والتي تتطلب دقة أكبر في الحفر وتوحيدًا في الطلاء الكهربائي، كما أنها معرضة لعيوب مثل فقاعات داخل الثقوب وانحناءات على السطح.
٢. ارتفاع تكاليف التصنيع: ستؤدي العمليات الخاصة إلى زيادة تكاليف لوحة الدوائر المطبوعة (PCB) بنسبة تتراوح بين ١٥٪ و٣٠٪، كما سيتم تمديد دورة الإنتاج بسبب عمليات الفحص الإضافية والإصلاح.