Via-in-Pad, yüksek yoğunluklu PCB tasarımımda kullanılan gelişmiş bir geçme delik teknolojisidir. Temel özelliği, kaplamalı geçme deliğini (PTH) doğrudan yüzeye monte edilen komponentin leğine entegre etmektir; deliğe bakır gibi iletken malzemelerin kaplanmasıyla elektriksel bağlantıyı sağlar ve deliği lehim maskesiyle kaplayarak kaynak güvenilirliğini temin eder.
Geleneksel geçitli deliklerin aksine, geleneksel PTH'ler genellikle komponent yama alanlarının dışında kalan kaynak yapılmayan bölgelerde düzenlenir ve yama alanlarına ek yollarla bağlanmaları gerekir; buna karşılık Via-in-Pad bu geçiş yapısından kaçınarak delik ve yama alanlarının doğrudan birleştirilmesine olanak tanır. Bu tasarım, yama alanının merkezinde bir "doğrudan kanal" açılması gibidir ve sinyal iletim yollarını önemli ölçüde kısaltarak sinyal gecikmesini ve kaybını azaltır. Uygulamalı değer açısından değerlendirildiğinde Via-in-Pad'in avantajları başlıca iki alana yoğunlaşmaktadır: alan kullanım oranı ve performans artışı. Deliği yama alanına yerleştirerek PCB üzerindeki yönlendirme alanını azaltmak mümkündür ve bu da ürünün küçülmesine yardımcı olur; aynı zamanda kısaltılan sinyal yolu, empedansdaki ani değişimi riskini azaltarak sinyalin bütünlüğünü geliştirir.
Ancak bu teknoloji, üretim sürecine daha yüksek talepler getirir: delme hassasiyetini (delik çapı genellikle ≤0,3 mm) ve delik duvarının bakır katmanı ile lehimleme yaması arasında güvenilir bir bağlantı sağlanması için elektrokaplama düzgünlüğünü dikkatle kontrol etmek gerekir; bazı tasarımlar ayrıca deliklerin reçine ile doldurulup yüzeyinin düzeltilmesini gerektirir, böylece kaynak sırasında hava kabarcıkları veya soğuk lehim birleşimlerinden kaçınılır. Bu nedenle, üretim maliyeti geleneksel PTH'den daha yüksektir ve genellikle yüksek yoğunluk ve yüksek performans gerektiren uygulamalarda tercih edilir.
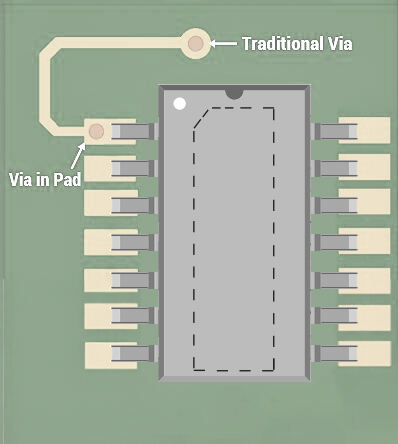
Via-in-pad uygulamasının PCB yerleşim yoğunluğu ve bileşen özellikleri ile birlikte değerlendirilmesi gerekir. Aşağıda özel senaryolar için tasarım önerileri yer almaktadır:
PCB yerleşimi ilk aşamasında uygun fan-out tasarımını tamamladıktan sonra, eğer iç katmanda yerleşim konvansiyonel geçit delikleri (via) ile sağlanabiliyorsa, via-in-pad kullanımına gerek yoktur. BGA paketli cihazları örnek verecek olursak, fan-out yolu pad'ler arasındaki merkezi alanda yer alıyorsa, geçit deliği ve yerleşim parametrelerini optimize ederek etkili bir yerleşim gerçekleştirilebilir. Tipik tasarım standartları aşağıdadır:
Yukarıdaki parametrelere göre, BGA pin aralığı 0,35mm'den büyükse, pad'ler arasındaki mesafe konvansiyonel geçit delikleri ve yerleşim için yeterli boşluğa sahiptir ve fan-out via-in-pad'e başvurmadan tamamlanabilir. Bu durumda, geleneksel bir tasarım seçmek, maliyet ile süreç güvenilirliği arasında daha iyi bir denge kurmanıza olanak sağlar.
Komponent pin aralığı çok küçük olduğunda, konvansiyonel fan-out işleminin gerçekleştirilmesi zorlaşır ve via-in-pad gerekli bir tercih haline gelir. Örneğin, yüksek yoğunluklu BGA paketlerinin lehim lebeleri arasındaki mesafe dar olduğundan, boyut sınırlamaları nedeniyle konvansiyonel via'lar ve hatlar düzenlenemez. Bu durumda via'lar doğrudan lehim lebelerine entegre edilmeli ve Via-in-Pad yöntemiyle iç veya alt katmanlı yönlendirme kanalları açılmalıdır; böylece hat yoğunluğundan kaynaklanan sinyal gecikmeleri veya yerleşim hataları önlenir.
Kısacası, via-in-pad'in temel kullanımı, "yüksek yoğunluklu yerleşimdeki yönlendirme darboğazı" sorununu çözmektir. Tasarım sırasında önce pin aralığı ve fan-out parametreleri ile uygulanabilirliği değerlendirmek, ardından performans, maliyet ve üretilebilirlik arasında optimal dengeyi sağlamak için bu yöntemin kullanılmasına karar vermek gerekir.
Düşük pin sayısına sahip BGA cihazlar için geleneksel fan-out tasarımı, Via-in-Pad'e başvurmadan yolların gereksinimlerini karşılayabilir. Ancak BGA çok sayıda pine sahip olduğunda, büyük miktarda fan-out viası sınırlı yolların üzerinde hızlıca yer kaplayarak sinyal yolunda tıkanıklığa neden olur. Bu durumda, via'ların Via-in-Pad içine entegre edilmesi, önce bağımsız olan "padya + via" birimlerini tek bir birim haline getirerek PCB yüzey alanı önemli ölçüde serbest bırakılır ve yüksek yoğunlukta yolların oluşturulmasına olanak sağlanır.
BGA pin adımı 0,3 mm'nin altına indiğinde padyalar arasında geleneksel via'lar ve yollar için yeterli alan kalmaz ve Via-in-Pad, yolların darboğazını aşmak için kilit bir yöntem haline gelir. Via'ları doğrudan padyaların içine yerleştirerek sinyal aynı katmanda yoğun yollar nedeniyle oluşan gecikmeleri veya çapraz girişimleri önlemek için doğrudan iç veya alt katmanlara yönlendirilir.
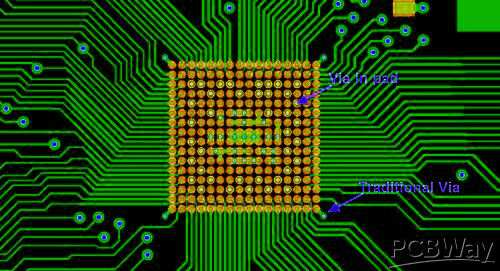
Yüksek hızlı devre tasarımı sırasında, güç gürültüsünü bastırmak ve sinyal bütünlüğünü sağlamak amacıyla filtre kapasitörleri genellikle BGA cihazlarına yakın konumlandırılır. Ancak, BGA'nın iç kısmında birçok geleneksel geçit deliği (through-hole) kullanılıyorsa, arka taraftaki geçit deliği alanı kapasitör yastıklarıyla "alan mücadelen"e girecek ve kapasitörün yongaya yakın konumlandırılamamasına neden olacaktır.
Via-in-Pad (Geçit Deliği-Pad Üzerinde), geçit deliklerini BGA yastıklarına entegre ederek arka taraftaki kapasitörlerle meydana gelen alan çakışmalarını tamamen önleyebilir. Bu da filtre kapasitörlerinin BGA'nın altında veya kenarında "yakın" bir şekilde konumlandırılmasına olanak tanıyarak güç yolunu kısaltır ve filtreleme verimliliğini artırır. Bu durum, yüksek frekanslı ve yüksek hızlı devrelerin kararlılığı için hayati öneme sahiptir.

1. Sonunda PCB yama alanını serbest bırakma: Plakaların ve deliklerin entegre tasarımı yüzey alanı kullanımını %30'dan fazla azaltabilir ve özellikle akıllı telefon ana kartları ve endüstriyel kontrol modülleri gibi yüksek yoğunluklu ve mini boyutlu tasarımlar için uygundur.
2. Isı dağılımı ve elektrik performansını artırma: İşlemciler ve güç yongaları gibi yüksek güçlü cihazlar için Via-in-Pad, termal direnci azaltabilir, ısının iç tabakaya veya soğutma tabakasına iletilmesini hızlandırabilir ve yerel aşırı ısınmayı önleyebilir; aynı zamanda kısaltılmış güç/sinyal yolu, sızıntı indüktansını ve direnci azaltarak sinyal zayıflamasını ve voltaj düşüşünü engeller.
3. Yerleşim esnekliğini artırma: Yüksek yoğunluklu paketleme altında "yetersiz yama kanalları" sorununu çözerek çok kanallı RF modülleri gibi karmaşık devrelerin yerleşimini daha esnek hale getirir.
1. Artan süreç karmaşıklığı: Daha yüksek delme hassasiyeti ve elektrokaplama düzgünlüğü gerektiren özel süreçler olan delik doldurma ve yüzey düzlendirme gibi işlemler gereklidir ve bu işlemlerde deliklerde hava kabarcıkları ve yüzey çukurları gibi hatalar oluşmaya meyillidir.
2. Artan üretim maliyetleri: Özel işlemler, PCB maliyetlerinin %15-%30 oranında artmasına neden olur ve ek kalite kontrolleri ve yeniden işlenme süreçleri üretim döngüsünü uzatır.