ビアインパッドとは、高密度PCB設計で使用される高度なスルーホール技術です。その主要な特徴は、表面実装部品のパッドに直接めっき済みスルーホール(PTH)を統合することで、スルーホール内に銅などの導電性材料を堆積させることにより電気的な接続を実現し、はんだマスクでその穴を覆うことではんだ付けの信頼性を確保します。
従来のスルーホールとは異なり、従来のPTH(スルーホール)は通常、部品パッドの外側の非溶接領域に配置され、追加のトレースを通じてパッドに接続する必要がありました。一方、Via-in-Pad(ビアインパッド)はこの中間構造を省略し、スルーホールとパッドを直接統合できます。この設計は、パッド中央に「直通路」を開けるようなもので、信号伝送経路を大幅に短縮し、信号遅延や損失を低減することができます。実用的な観点から見ると、ビアインパッドの利点は主に2つあります。スペースの有効利用と性能向上です。スルーホールをパッド内に埋め込むことで、プリント基板上の配線スペースを削減でき、製品の小型化に貢献します。同時に、信号経路が短くなることでインピーダンス不連続のリスクを低減し、信号の完全性を向上させます。
ただし、この技術は製造プロセスに高い要求を課します。ドリル加工精度(ホール径は通常≤0.3mm)と、ホール内壁の銅層とパッドとの信頼性のある接続を確保するためのめっき均一性を正確に制御する必要があります。また、一部の設計では、溶接時の気泡や冷めはを防ぐために、ホールに樹脂を充填し、平坦化することが求められます。したがって、従来のPTHに比べて製造コストが高くなるため、高密度・高性能が要求される用途で主に採用されます。
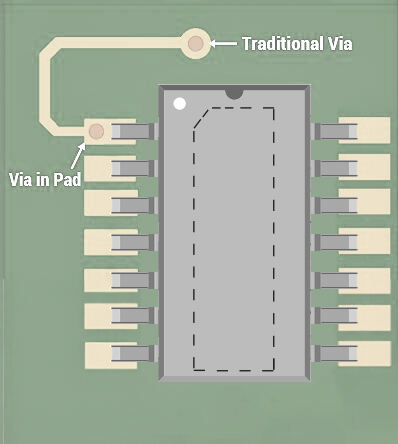
パッド内ビアの適用は、PCBのレイアウト密度や部品特性を総合的に判断して決定する必要があります。以下に特定のシナリオにおける設計推奨事項を示します。
PCB配線の初期段階でファンアウト設計を完了した後、内層の配線が従来のビアによって実現できる場合は、ビアインパッドを使用する必要はありません。BGAパッケージのデバイスを例に挙げると、ファンアウト経路がパッド間の中央領域にある場合、ビアおよび配線パラメータを最適化することにより効率的な配線が可能になります。一般的な設計基準は以下の通りです。
上記のパラメータに基づき、BGAピン間隔が0.35mmより大きい場合、パッド間のスペースが十分で、従来のビアと配線を収容でき、ビアインパッドに依存せずにファンアウトを完了できます。このような状況では、従来の設計を選択することでコストと工程信頼性のバランスをより適切に取ることが可能です。
コンポーネントのピン間隔が狭く、従来のファンアウトが困難な場合、パッド内ビア(Via-in-Pad)は必要不可欠な選択となります。例えば、高密度BGAパッケージのパッド間のスペースが狭いため、サイズの制約により従来のビアや配線を配置することが出来ません。このような状況では、ビアを直接パッドに埋め込み、Via-in-Padによって内層または裏面層の配線チャンネルを開けることで、配線の混雑による信号遅延やレイアウト不良を回避します。
要約すると、Via-in-Padのコアとなる応用は、高密度レイアウトにおける「配線ボトルネック」を解決することです。設計時には、ピン間隔やファンアウトのパラメータを通じて実現可能性をまず評価し、性能・コスト・製造性の最適なバランスを達成するために採用するかどうかを決定する必要があります。
ピン数の少ないBGAデバイスの場合、従来のファンアウト設計により、Via-in-Padに依存することなく配線要件を満たすことができます。しかし、BGAのピン数が多くなると、多数のファンアウトビアが限られた配線スペースをすぐに占拠し、信号経路の混雑を引き起こします。このような場合、ビアをVia-in-Padに統合することで、もともと独立していた「パッド+ビア」を一体化することが可能となり、PCB表面のスペースを大幅に節約し、高密度配線の条件を整えることができます。
特にBGAピンピッチが0.3mm未満まで縮小された場合、パッド間には従来のビアや配線を配置するための十分なスペースが確保できず、Via-in-Padは配線ボトルネックを突破する重要な手段となります。パッド内部にビアを埋め込むことで、信号を直接内層または最下層に誘導し、同一層上で密集した配線による信号遅延や交差干渉を回避することが可能になります。
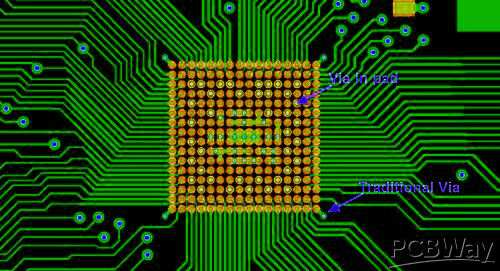
高速回路設計において、フィルタコンデンサは通常、BGAデバイスの近くに配置され、電源ノイズを抑圧し、信号の完全性を確保します。ただし、BGA内部で多数の従来のスルーホールを使用する場合、裏面のスルーホール領域がコンデンサパッドと「領域の競合」を起こし、コンデンサをチップピンに近接して配置できなくなります。
パッド内実装ビア(Via-in-Pad)は、スルーホールをBGAパッドに統合することで、裏面のコンデンサとの空間的な干渉を完全に回避できます。これにより、フィルタコンデンサをBGAの下部または端部に「密接」に配置でき、電源パスを短縮し、フィルタリング効率を向上させます。これは高周波・高速回路の安定性にとって極めて重要です。

1. 最終的にPCB配線スペースを解放:ビアとパッドの一体化設計により、表面の占有スペースを30%以上削減でき、スマートフォンのマザーボードや産業用制御モジュールなどの高密度・小型化設計に特に適しています。
2. 放熱性および電気性能の向上:プロセッサーや電源チップなどの高電力デバイスにおいて、パッド内ビア(Via-in-Pad)は熱抵抗を低減し、熱伝導を内層または放熱層へと促進し、局所的な過熱を回避します。同時に、電源/信号経路が短縮されることで寄生インダクタンスや抵抗を低減し、信号減衰や電圧降下を抑えることができます。
3. レイアウトの柔軟性の向上:高密度パッケージングにおける「配線チャネル不足」の課題を解決し、多チャンネルRFモジュールなどの複雑な回路のレイアウトをより柔軟に行うことができます。
1. プロセスの複雑化:穴埋めや表面の平坦化といった特別工程が必要であり、ドリリング精度やめっき均一性の要求水準が高くなり、穴に気泡が生じたり、表面に凹みが生じたりするなどの欠陥が発生しやすくなります。
2. 製造コストの増加:特別工程によりプリント基板(PCB)コストが15〜30%増加し、追加の品質検査や再作業のため製造サイクルも延長されます。