HDI基板はHigh-Density Interconnect Printed Circuit Boardの略称です。その名前からも分かるように、これは電子製品の小型化と高性能化の要求に応えるために設計された高級基板です。高密度基板は微細な配線と微細なビアピッチを特徴としています。従来の基板と比較して、HDI基板は配線密度を最適化するために配線幅を縮小し、従来のスルーホール(Through Hole Via)プロセスをやめ、レーザードリルを用いたマイクロビア(Micro Via)、ブラインドビア(Blind Via)、バーリッドビア(Buried Via)および積層技術を採用しています。これにより、回路の集積度が従来の基板をはるかに超え、単位面積あたりにさらに多くの部品を搭載することが可能となり、限られた空間内でより複雑な回路機能を実現し、小型化された電子製品に高い性能を持たせることができるため、軽量化・知能化・高周波化に向かう電子製品時代のニーズに正確に対応し、5G、IoT、人工知能などの新興分野における技術的飛躍を支える重要な基盤となっています。
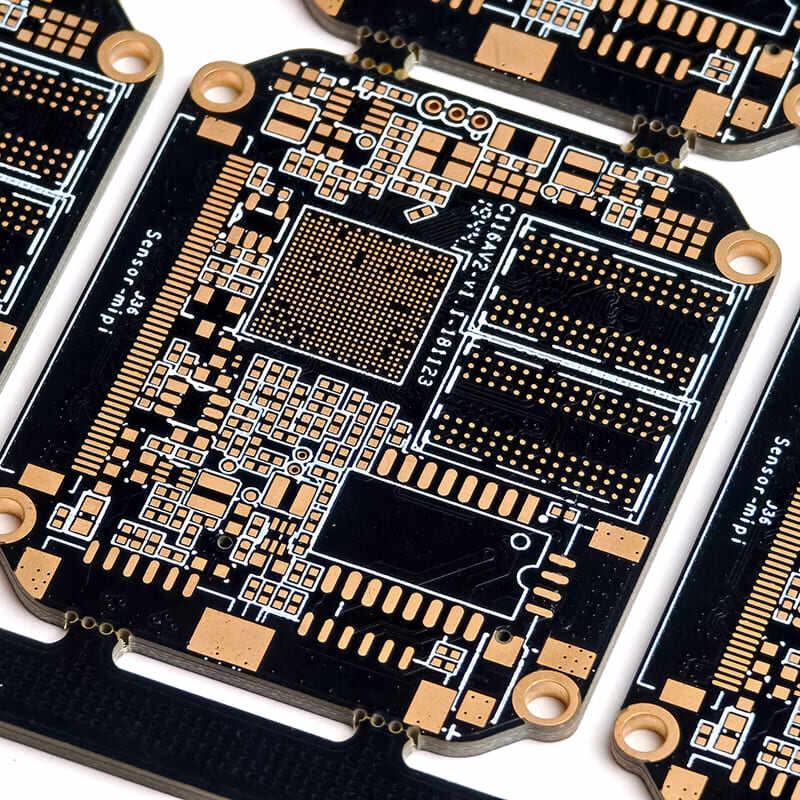
独自の設計および工程により、高密度インターコネクト基板(HDI基板)は高密度および高性能のニーズに対応する一連のコア特徴を持っており、主に以下の通りです:
HDI回路基板は通常、層数が多く、一般的に4層より多いです。これは、層数が少ないと配線の混雑や信号干渉を避けるのが難しくなるため、層数を増やして配線や接続を複数の層に分散し、合理的な配置を行う必要があるからです。多くの製品では、機能の複雑さに応じて6層から12層の設計が選ばれ、限られた空間内で配線密度、機能的複雑さ、回路性能のバランスを実現します。
電子機器の小型化のニーズに応え、限られた空間でより高密度な回路統合を実現するため、HDI基板は配線を効率的に配置する必要があります。HDI基板は3〜5ミル、あるいはそれ以下の線幅および線間隔を実現できますが、従来の回路基板の配線間隔は通常数百マイクロメートルです。したがって、HDI基板を製造する際、ほん slightest な工程のずれでも配線の変形や短絡、開放などが発生し、極めて処理が困難です。
HDI基板におけるホール設計も非常に微細です。ホールの種類には以下のようなものがあります。Microvia(マイクロバイア)は通常6mil未満のホール径を持ち、微細な配線を正確に接続し、スペースを節約する目的で使用されます。複数の層の接続を実現するためには、多くの場合、層ごとに積み重ねる必要があり、これらのホールは銅で充填または電解めっきすることが求められます。Blind Via(ブラインドバイア)は表面層から特定の内部層まで延びており、片側にのみ見えます。これはセグメント化されたドリル工程によって実現され、信号経路を効果的に短くし、層間干渉を軽減します。Buried Via(バーリッドバイア)は完全に内部層に埋め込まれており、表面層を貫通しません。これは多段階の積層工程によって製造され、表面配線のスペースを開放し、内部の電源/グランド層の完全性を高めます。Staggered Via(スタガーバイア)は複数のマイクロバイアが階段状に配置され、ステップ状の接続構造を形成し、クロス層接続が必要でスペースが限られている場面に適しています。Stacked Via(スタックドバイア)は複数のマイクロバイア層が垂直に積み重なり、柱状の構造を形成し、多層間の直接接続を実現しますが、電気的な信頼性を確保するためには、ドリル精度を厳密に管理する必要があります。これらのホールタイプを合理的に組み合わせて使用することで、高密度・高性能のPCB設計要件を満たすことができます。
配線をより密にするために、HDIはVIP技術も採用し、これはパッドに直接マイクロホールを掘削し、それを細い線で接続することで配線チャネルを広げ、高密度のシナリオにおける配線混雑の問題を解決するものです。パッドとホールの空間位置関係により、以下のタイプに細分化できます。
HDI基板のホール構造レイアウトは、高密度相互接続および信号完全性の要件を満たす必要があります。製造時には、層間のアラインメント精度(±15μm以内)を正確に制御して、アスペクト比を1:3以下に保ち、信号伝送の安定性を確保する必要があります。また、コア層にはより厚い基材を使用し、埋め込みビア構造により中間層の電気的導通性を高めることで、高密度・高性能電子機器の応用要求をより適切に満たすことができます。
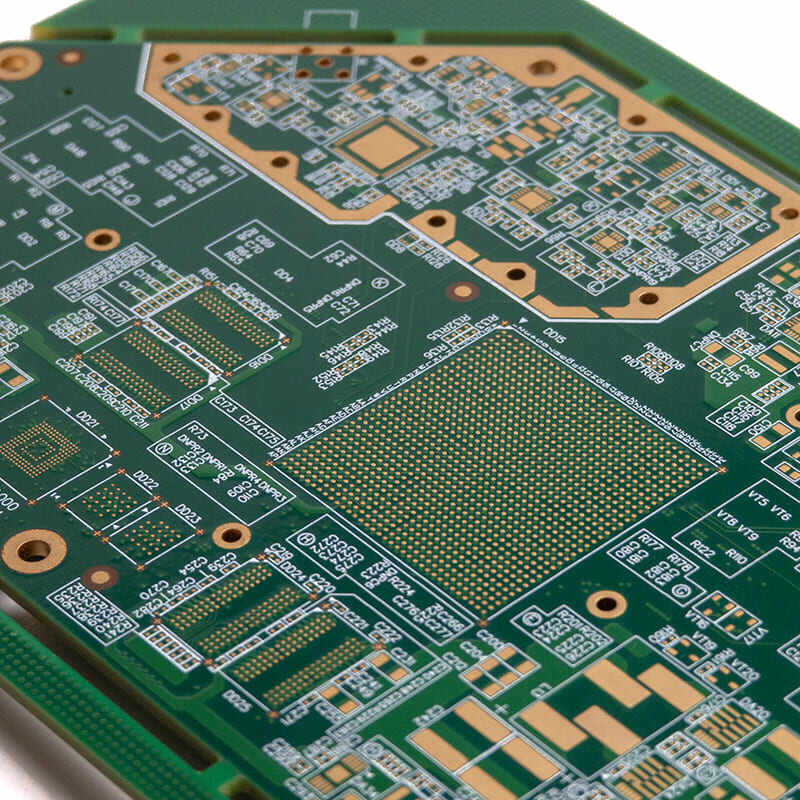
HDI基板は積層およびラミネート工程において特有の特性を示します:
伝統的なPCBと同じ層ごとの構築ロジックを使用するものの、多層のブラインドビアやバーリードビアによる複雑な相互接続設計を実現するには、複数回の積層および圧着工程が必要です。その構造は厚いコア層を基盤とし、両面に薄い誘電体層を対称的に積層して構成されており、高密度配線に適した基盤となっています。
特定の製造プロセスは以下の通りです:最初にネガティブフォトレジストフィルムで導電領域を定義し、塩化鉄を使用して不要な部分をエッチングします。次に化学溶液を使用してフォトレジストフィルムを除去し、処理する基板を露出させます。ドリリング工程では、密度要件に応じて機械式、レーザー式、または化学的方法を選択します。その後、メタライゼーションプロセスを通じて内層回路の相互接続を完成させます。最後に、外層構造が形成されるまで積層およびめっき操作を繰り返し、高密度環境における高精度の相互接続要件を満たします。
特徴 |
能力 |
| 品質グレード | 標準 IPC 2 |
| 層数 | 4~32層 |
| 線幅/線間隔 | 1.5~2mil(0.035~0.05mm) |
| 最小機械ドリル径 | 0.2mm |
| 最小レーザードリル径 | 半径0.1mm |
| ブラインド/埋設ビア | 0.1~0.2mm |
| ビアホール(PTH) | ≥0.3mm |
| ビアアパーチャ比 | 8mil(0.2mm) |
| 配線間隔/パッド間隔 | 3mil(0.075mm) |
| 最小パッドサイズ | 0.15~0.4mm |
| ソルダーマスク間隔 | ≥3mil (0.075mm) |
| ソルダーマスクの色 | 緑、白、青、黒、赤、黄、紫 |
| 板厚 | 0.4~1.6mm |
| 材料 | 高Tg FR4、ネルコN7000-2 HT、イソラI-Speedおよびその他の低損失材料 |
| スタッキング法 | 順次積層 |
| 微小孔充填 | レジン充填/電解メッキ充填 |
| 金属層の厚さ | 1oz-2oz(35μm-70μm) |
| 最小穴間隔 | ≥0.2mm |
HDI基板(高密度相互接続プリント基板)は、電子機器の小型化・高性能化のトレンドにおいて、独自の設計とプロセスにより顕著な利点を示しており、主に以下の点に表れています:
精密技術により、HDIは限られた領域内で多数の配線接続を実現できます。従来のプリント基板と比較して、同じ機能を持つ条件下で体積を30〜50%削減し、機器の軽量化を実現します。これにより、機器のスペースと軽量化の基盤を提供します。
HDI基板の製造コストは比較的高いものの、部品点数を削減し、空間利用率を最適化し、組立工程を簡素化することで、システム全体の設計・製造コストを大幅に削減できます。長期的にはコストパフォーマンスが向上します。
多層プロセスは6〜12層、あるいはそれ以上の層数に対応しています。ステップ穴やスタッキング穴などの構造と組み合わせることで、複雑な回路のトポロジーを柔軟に設計できます。
短く直線的な信号経路により、不要なインダクタンスと静電容量を低減し、ノイズを効果的に抑制し、信号伝送の遅延と損失を軽減します。また、多層構造により、電源層、グランド層、信号層を分離することで、電磁妨害(EMI)を低減できます。
小型機器の急速な開発・試験プロセスに対応し、高集積化と設計の柔軟性により、試作から量産までのサイクルを短縮し、市場のニーズに迅速に対応できる製品を実現します。
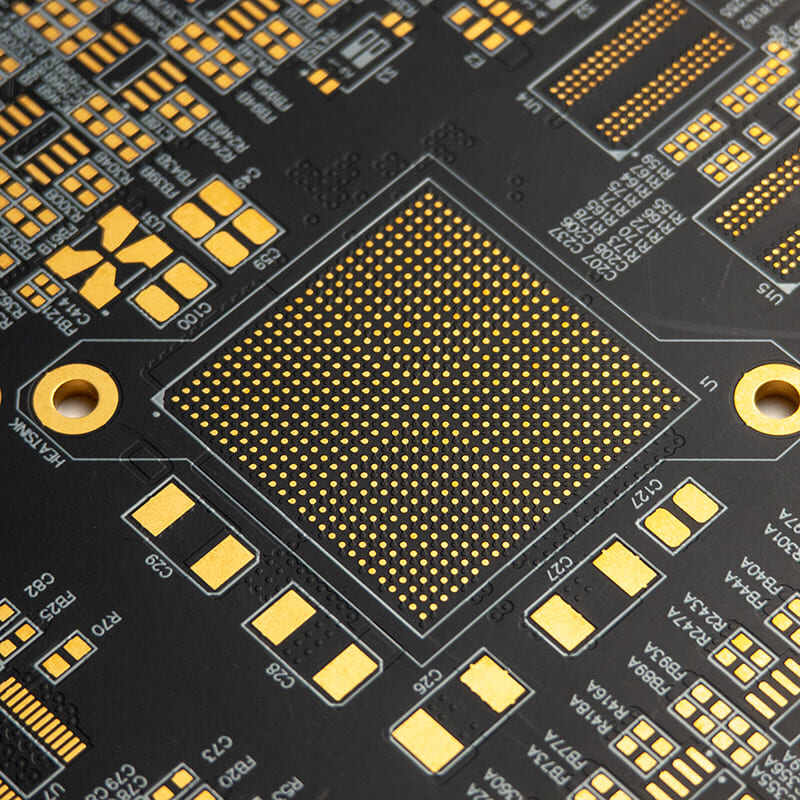
アルミニウム基板には多くの利点がありますが、いくつかの欠点もあります:
スマートフォン、タブレット、スマートウォッチなどのポータブルデバイスや拡張現実(AR)・仮想現実(VR)製品などは、高解像度ディスプレイやセンサー、プロセッサーなどのコンポーネントを狭い空間に統合する必要があります。HDIの高密度配線技術は、こうした製品の小型設計と高性能化の要件を満たすことができます。
自動運転システムや車載インフォテインメントシステムなどは、車内の限られたスペースにおいて高速プロセッサーおよびRAMとの高速配線を実現し、低クロストーク、高互換性、信号完全性などの要件を満たす必要があります。また、複数センサー間のデータやり取りや高速演算処理を想定した設計が求められます。
5G基地局、ルーター、衛星通信端末などは、HDIによる高周波信号伝送の最適化、遅延や干渉の低減、高帯域幅データ通信をサポートする機能に依存しています。
ポータブルモニター、超音波機器、低侵襲手術ロボット、カプセル内視鏡などは、小型化設計と正確な信号制御が必要とされます。HDIは、高安全性基準と動作精度要求を満たしつつ、体積と性能のバランスを実現できます。
ドローン、人工衛星搭載機器、レーダーシステムなどの軍用・宇宙機器は、高出力・高感度部品を統合しており、データ精度、通信の信頼性、軽量化に対して極めて高い要求があります。HDIの軽量構造と信頼性の高い接続技術は、過酷な環境下でも性能要件を満たすことができます。
高精度CNC工作機械や産業用ロボットの制御システムでは、多軸連動信号伝送をサポートするために高密度配線が必要です。HDIは機器の応答速度と運転安定性を向上させることができます。
HDI基板の設計は高密度かつ高性能の要件を満たすことができますが、同時に複数の 技術的課題にも直面しており、主に以下の側面に表れています:
1. 設計および製造の適応性。これは製造可能性設計(DFM)ガイドラインに厳密に従う必要があり、設計が生産能力に適合することを保証しなければならない。
2. 層数の計画。これは通常、BGAデバイスのお勧め基準を指すか、または配線方向および長さの総合的な判断に基づき、後続の設計の基盤を築く。
3. ホール構造の設計。ホールの配置は基板の厚みおよび層数の合理的な設定に直接影響し、各層の配線を接続する鍵となる。
4. 組立信頼性および環境適応性。使用中に基板が破損しないことを保証し、耐久性および安定性を考慮に入れる必要がある。
5. メーカーの技術力は、基板全体の製造性、配線品質および最終的な動作効果に直結するプロセスレベルによって直接関係します。
高密度相互接続基板(HDI PCB)の場合、その生産、製造および設計工程は、IPCが制定したIPC-2315、IPC-2226、IPC-4104、IPC-6016などの一連の規格に厳密に従う必要があります。
HDI PCBの製造と標準PCBとの間には多くの違いがあり、その制約は主に材料およびプロセスの互換性に現れます。
1. 基材は電気的および機械的特性の両方の要求を満たす必要があり、誘電体材料は高耐熱性(TG値)、熱衝撃性および金属溶接性と互換性がある必要があります。また、マイクロビア、埋め込みビア、ブラインドビアなど各種ビアタイプとも互換性を持つ必要があります。
2. マイクロビアや埋込みビアなどの領域における銅箔の付着性および性能の安定性は信頼性がなければならない。
さらに、この材料は良好な熱安定性を持ち、はんだ付けや熱サイクル時の衝撃に耐える必要がある。
関連規格にはIPC-4101BおよびIPC-4104Aがあり、フォトレジスト液誘電体層、ドライフィルム誘電体層、ポリイミドフィルム、熱硬化性フィルム、樹脂被覆銅箔、標準FR-4などが含まれる。
世界的に成長を続けるHDIプリント基板産業において、中国は主要な製造拠点となり、多くの高品質メーカーが台頭しています。その中でもPCBallyはリーダー的存在です。豊富な経験と革新力により、PCBallyはさまざまな面で顕著な強みを示しています: