HDI doska plošných spojov je skratka pre dosku plošných spojov s vysokou hustotou prepojenia. Ako už jej názov napovedá, ide o pokročilú dosku plošných spojov, ktorá je navrhnutá tak, aby spĺňala požiadavky elektronických výrobkov na miniaturizáciu a vysoký výkon. Dosky plošných spojov s vysokou hustotou sa vyznačujú jemnými vodičmi a jemným rozostupom otvorov. Oproti tradičným doskám plošných spojov optimalizujú hustotu vodičov znížením počtu vodičov, zanechávajú tradičný proces prechodných vývodov (Through Hole Via), uplatňujú laserové vŕtanie, ako sú mikrospojky (Micro Via), slepé vývody (Blind Via), vložené vývody (Buried Via) a technológiu vrstvenia, čím dosahujú výrazne vyššiu integráciu obvodov v porovnaní s tradičnými doskami plošných spojov. Môžu tak obsiahnuť viac komponentov na jednotku plochy, umožňujú realizovať zložitejšie funkcie obvodov v obmedzenom priestore a zabezpečujú, aby elektronické výrobky mali v menšom objeme silnejší výkon. Tým presne reagujú na požiadavky doby, keď smerujú elektronické výrobky k ľahkosti, inteligencii a vysokým frekvenciám, a stávajú sa kľúčovým nositeľom prelomov v nových oblastiach, ako sú 5G, internet vecí a umelej inteligencie.
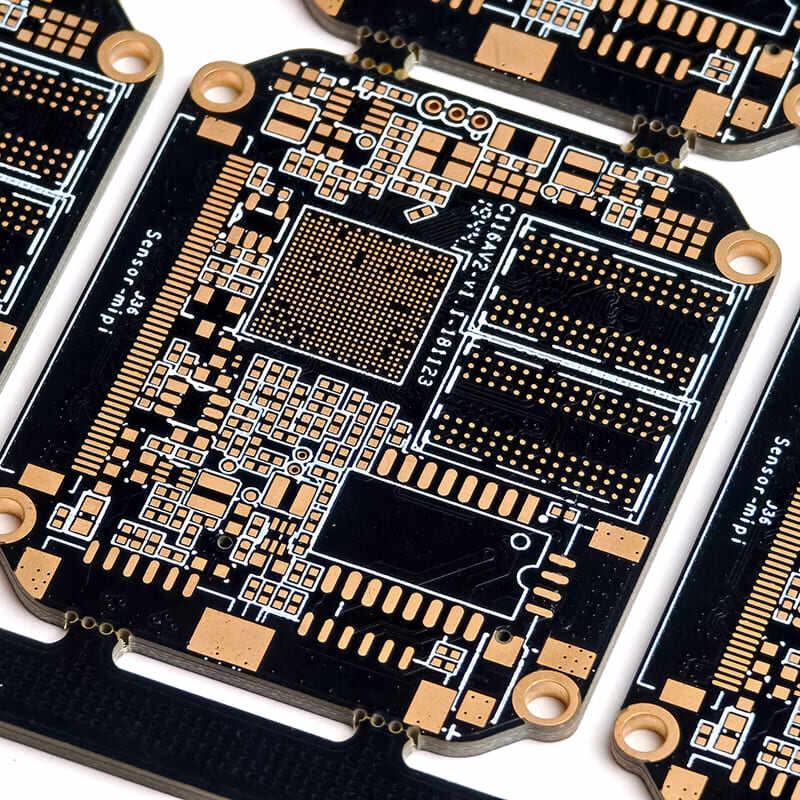
Vďaka svojmu jedinečnému dizajnu a technológií, dosky s vysokou hustotou spojov (HDI) vykazujú rad kľúčových vlastností, ktoré spĺňajú požiadavky na vysokú hustotu a vysoký výkon. Medzi tieto vlastnosti patria hlavne:
HDI dosky sú zvyčajne viacvrstvové, väčšinou viac ako 4 vrstvy. Je to preto, že pri niekoľkých vrstvách je ťažké sa vyhnúť preťaženiu vodičov a rušeniu signálov, a preto je potrebné zvýšiť počet vrstiev a rozložiť vedenia a spoje na viaceré vrstvy pre účelné plánovanie. Väčšina výrobkov si na základe zložitosti funkcií vyberie 6- až 12-vrstvový dizajn, aby v obmedzenom priestore dosiahla rovnováhu medzi hustotou vedení, zložitosťou funkcií a výkonom obvodu.
Aby boli schopné vyhovieť miniaturizácii elektronických zariadení a dosiahnuť vyššiu hustotu integrácie obvodov v obmedzenom priestore, musia si hdi dosky efektívne rozdeľovať vodiče. Hdi doska môže dosiahnuť šírku a rozstup vodičov 3–5 mil alebo dokonca menší, zatiaľ čo rozstup vodičov tradičných dosák je zvyčajne niekoľko stoviek mikrónov. Preto akékoľvek mierne odchýlky v procese výroby hdi plošných spojov môžu spôsobiť deformáciu vodičov, skrat alebo prestávku, čo je extrémne ťažko spracovateľné.
Dierkovanie v HDI doskách je tiež veľmi jemné. Typy dierok zahŕňajú: Microvia, ktorá zvyčajne má priemer dierky menší ako 6mil, aby umožnila presné prepojenie jemných vodičov a ušetrila priestor. Aby bolo možné dosiahnuť prepojenie medzi viacerými vrstvami, je často potrebné ich postupne nad seba vrstviť, pričom dierky sa zvyčajne musia vyplniť meďou alebo poniklovať; Blind Via, ktorá vedie od povrchovej vrstvy ku konkrétnej vnútornej vrstve a je viditeľná iba z jednej strany. Toto sa dosahuje postupným vŕtaním, čo efektívne skracuje dĺžku signálnej trate a znižuje interferenciu medzi vrstvami; Buried Via, ktorá je úplne zabudovaná vo vnútornej vrstve a neprechádza povrchovou vrstvou. Jej výroba vyžaduje viacstupňový proces laminovania, čo uvoľní priestor na plošných spojoch na povrchu a zlepší integritu vnútorných napájacích/vývodových plôch; Staggered Via, ktorá je zložená z viacerých vzdialených mikrodierok, ktoré vytvárajú schodovú štruktúru prepojenia, vhodná pre scenáre, kde sú potrebné prepojenia medzi vrstvami, ale priestor je obmedzený; Stacked Via, kde viaceré vrstvy mikrodierok sú zvisle nad sebou a vytvárajú stĺpcovú štruktúru, čo umožňuje priame prepojenie medzi viacerými vrstvami, avšak presnosť vŕtania musí byť prísne kontrolovaná, aby sa zabezpečila elektrická spoľahlivosť. Rozumné kombinovanie a použitie týchto typov dierok môže spĺňať nároky na návrh vysokohustotných a vysokovýkonných plošných spojov.
Aby sa zapojenie mohlo vykonať hustejšie, HDI bude používať aj VIP technológiu, t. j. priame vŕtanie mikrodiier v plôškach a ich prepojenie tenkými linkami, čím sa rozšíri kanál zapojenia a vyrieši sa problém súčasného zaplnenia liniek v prípade vysokých hustôt. Podľa priestorového vzťahu medzi plôškami a dierami sa môže rozdeľovať na nasledovné typy:
Rozloženie otvorov na doske HDI PCB musí spĺňať požiadavky na vysokú hustotu prepojenia a integritu signálu. Počas výroby je potrebné presne kontrolovať presnosť zarovnania medzi vrstvami (v rámci ±15 μm), aby sa dosiahlo nízke pomery strán ≤1:3, čo zabezpečí stabilnú prenosovú funkciu signálu; jadrová vrstva využíva hrubšiu substrátovú dosku, a dizajn vložených otvorov môže vylepšiť elektrické prepojenie strednej vrstvy, čím sa lepšie spĺňajú požiadavky na vysokú hustotu a výkon elektronických zariadení.
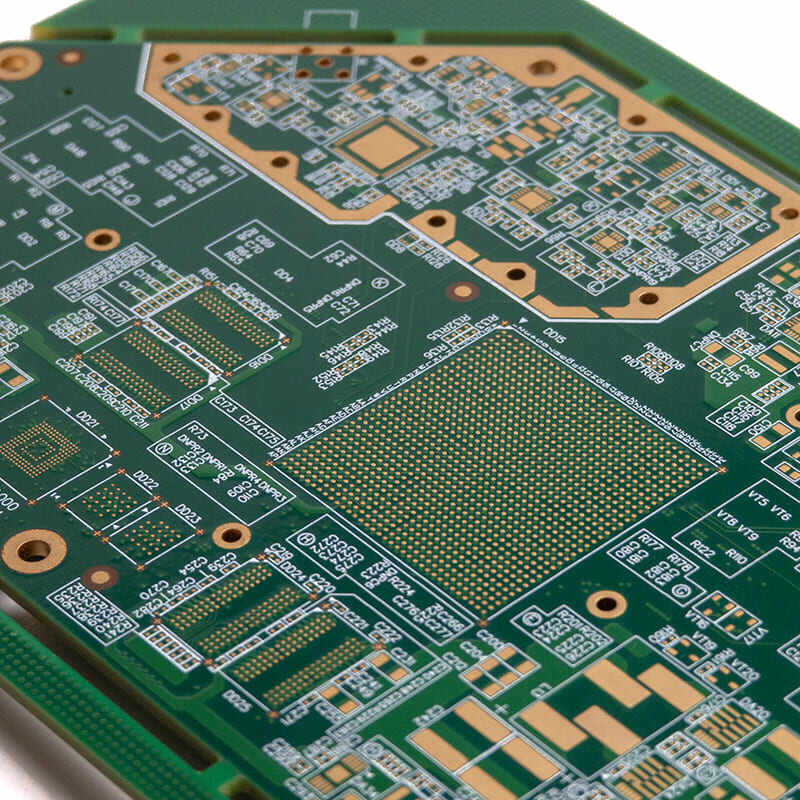
HDI PCB má pri procesoch vrstvenia a laminovania špecifické vlastnosti:
Hoci využíva vrstvenú konštrukčnú logiku ako tradičné dosky plošných spojov (PCB), na dosiahnutie zložitých interkonekčných návrhov s viacvrstvovými slepými a skrytými vývodmi je potrebné niekoľko kolón laminovania a vrstvenia. Jeho štruktúra vychádza z hrubej nosnej vrstvy, na ktoré sú symetricky nanášané tenké dielektrické vrstvy na oboch stranách, čím vzniká infraštruktúra vhodná pre vysokohustotné zapojenie.
Špecifický výrobný proces je nasledovný: najprv sa fotorezistovou fóliou definuje vodivá plocha a zbytočné časti sa odstránia trávením chloridom železitým; potom sa fotorezistová fólia odstráni chemickým roztokom, aby sa odkryla substrátová plocha určená na spracovanie; vŕtacie procesy sa vykonávajú mechanickou, laserovou alebo chemickou metódou v závislosti od požiadaviek na hustotu; následne sa medzi vrstvami dosky sa uskutoční prepojenie obvodov prostredníctvom metalizačného procesu; nakoniec sa opakujú procesy laminácie a poniklovanie, až kým sa vytvorí vonkajšia štruktúra, čím sa dosiahne požadovaná presnosť prepojenia v prípade vysokohustotných aplikácií.
Funkcia |
Schopnosť |
| Kvalitná trieda | Norma IPC 2 |
| Počet Podlážok | 4-32 vrstiev |
| Šírka vodiča/Vzdialenosť vodičov | 1,5~2mil (0,035~0,05mm) |
| Minimálna mechanická vývrtka | 0.2mm |
| Minimálna laserová vývrtka | 0,1 mm |
| Slepé/Zakonzervované vývrtky | 0,1~0,2mm |
| Vrtaná diera (PTH) | ≥0,3 mm |
| Pomer otvoru vodiča | 8mil (0,2mm) |
| Vzdialenosť vodičov/vzdialenosť plôšok | 3mil (0,075mm) |
| Minimálna veľkosť plôšky | 0,15~0,4mm |
| Vzdialenosť lútovacej masky | ≥3mil (0,075mm) |
| Farba lútovacej masky | Zelená, biela, modrá, čierna, červená, žltá, fialová |
| Hrúbka plechu | 0,4~1,6 mm |
| Materiály | Vysokoteplotný FR4, Nelco N7000-2 HT, Isola I-Speed a iné materiály s nízkymi stratami |
| Spôsob skladovania | Postupné vrstvenie |
| Vyplnenie mikropórov | Vyplnenie pryskyricou/vyplnenie elektrolytickým zinkovaním |
| Hrúbka kovovej vrstvy | 1 oz-2 oz (35 μm-70 μm) |
| Minimálna vzdialenosť medzi otvormi | ≥0,2 mm |
HDI doska plošných spojov (doska s vysokou hustotou prepojení) preukázala významné výhody v trende miniaturizácie a vysokého výkonu elektronických zariadení vďaka svojmu jedinečnému dizajnu a technológiám, čo sa odráža najmä v nasledujúcich aspektoch:
Vďaka presným technológiám môže HDI dosiahnuť masové pripojenie vodičov v obmedzenom priestore. V porovnaní s tradičnými doskami plošných spojov môže pri rovnakých funkciách zredukovať objem o 30 % - 50 %, zároveň znížiť hmotnosť zariadenia a poskytnúť priestorový a ľahký základ pre zariadenie.
Hoci sú výrobné náklady HDI dosiek relatívne vysoké, náklady na návrh a výrobu celého systému je možné výrazne znížiť prostredníctvom zníženia počtu súčiastok, optimalizácie využitia priestoru a zjednodušenia montážneho procesu, čím sa dosiahne lepšia nákladová efektívnosť na dlhú trať.
Viacvrstvový proces podporuje 6-12 vrstiev alebo dokonca viac vrstiev. V kombinácii so štruktúrami, ako sú stupňovité otvory a nakladené otvory, je možné flexibilne plánovať zložité topológie obvodov.
Krátke a priame cesty signálov znižujú parazitnú indukčnosť a kapacitu, účinne kontrolujú šum, znižujú oneskorenie a straty pri prenose signálov; viacvrstvová štruktúra môže oddeliť vrstvy napájania, uzemnenia a signálov, čím sa zníži elektromagnetické rušenie (EMI).
Prispôsobenie sa rýchlemu vývojovému a testovaciemu procesu kompaktných zariadení, vďaka svojej vysoká integrovanej výstavbe a návrhovej flexibilite skráti cyklus od prototypu po sériovú výrobu, čo pomáha produktom rýchlej reagovať na trh.
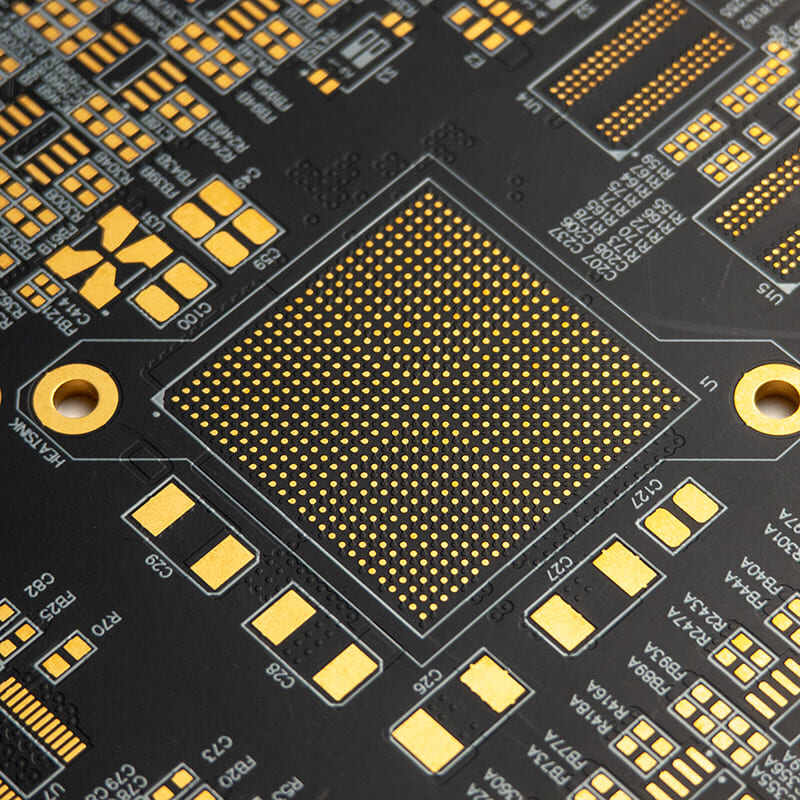
Hliníkové dosky plošných spojov majú aj keď veľa výhod, majú aj niektoré nevýhody:
Prenosné zariadenia, ako sú smartfóny, tablety, chytré hodinky a produkty, ako sú rozšírená realita (AR) a virtuálna realita (VR), musia integrovať displeje s vysokým rozlíšením, senzory, procesory a ďalšie komponenty v malom priestore. Vysoká hustota interkonekcií (HDI) dokáže spĺňať ich požiadavky na kompaktný dizajn a vysoký výkon;
Systémy automatického vedenia, palubné infotainmentové systémy a podobne musia dosiahnuť vysokorýchlostné zapojenie vysokorýchlostných procesorov a pamätí RAM v obmedzenom priestore vozidla, spĺňať požiadavky na nízku diaľkovú väzbu, vysokú kompatibilitu a integritu signálu a prispôsobiť sa interakcii údajov z viacerých senzorov a vysokorýchlostným výpočtovým scenárom;
základňové stanice 5G, smerovače, terminály satelitnej komunikácie a podobne sa spoliehajú na HDI pri optimalizácii prenosu vysokofrekvenčných signálov, znížení oneskorení a rušení a podpore interakcie údajov s vysokou priepustnosťou;
Prenosné monitory, ultrazvukové zariadenia, robotické systémy pre minimálne invazívne chirurgické zákroky, kapsulové endoskopy atď. vyžadujú miniaturizovaný dizajn a presnú kontrolu signálov. HDI môže vyvážiť objem a výkon, pričom spĺňa vysoké štandardy bezpečnosti a požiadavky na prevádzkovú presnosť;
Vojenské a letecké zariadenia, ako sú drony, užitočné zaťaženie satelitov a radarové systémy, integrujú výkonovo náročné a vysoko citlivé komponenty a kladú mimoriadne vysoké požiadavky na presnosť údajov, spoľahlivosť komunikácie a ľahkosť. Ľahká konštrukcia HDI a spoľahlivá interkonekčná technológia môžu spĺňať výkonové požiadavky v extrémnych prostrediach;
Riadiace systémy presných CNC strojov a priemyselných robotov vyžadujú vysokohustotné vedenie, aby podporovali prenos signálov pri viacosebnej súčinnej regulácii. HDI môže zlepšiť rýchlosť reakcie a prevádzkovú stabilitu zariadení.
Hoci návrh dosiek plošných spojov HDI môže spĺňať požiadavky na vysokú hustotu a vysoký výkon, čelí aj viacerým technickým výzvam, ktoré sa prejavujú najmä v nasledujúcich oblastiach:
1. Prispôsobivosť dizajnu a výroby, ktorá musí prísne sledovať smernice pre dizajn vhodný na výrobu (DFM), aby sa zabezpečilo, že dizajn bude zodpovedať výrobným kapacitám;
2. Plánovanie počtu vrstiev, ktoré sa zvyčajne odvoláva na odporúčané štandardy BGA súčiastok alebo je založené na komplexnom posúdení smeru a dĺžky prepojenia siete, čím sa zakladá základ pre následný dizajn;
3. Dizajn štruktúry otvorov, rozmiestnenie otvorov priamo ovplyvní rozumné nastavenie hrúbky a počtu vrstiev dosky a je kľúčové pre prepojenie vedení jednotlivých vrstiev;
4. Spoľahlivosť pri montáži a prispôsobivosť prostrediu, je potrebné zabezpečiť, aby sa doska počas používania nepretrhla a zohľadniť trvanlivosť a stabilitu;
5. Technická sila výrobcu, ktorého procesná úroveň súvisí s výrobnou možnosťou celej dosky, kvalitou vodičov a konečným prevádzkovým efektom.
Pri výrobe PCB s vysokou hustotou prepojení musia byť výrobné, výrobe a návrhové kroky prísne vykonávané v súlade so sériou štandardov IPC vrátane IPC-2315, IPC-2226, IPC-4104 a IPC-6016.
Medzi výrobou HDI dosiek a bežných PCB existuje veľa rozdielov, pričom ich obmedzenia sa odrážajú hlavne v kompatibilite materiálov a procesov:
1. Základný materiál musí spĺňať požiadavky na elektrické aj mechanické vlastnosti, dielektrický materiál musí byť kompatibilný s vysokou hodnotou TG, odolnosťou proti tepelnému šoku a kovovou pájkou a musí byť kompatibilný s rôznymi typmi otvorov, ako sú mikrootvory, vložené otvory a slepé otvory;
2. Adhézia a stabilita výkonu medeného plechu v oblastiach ako mikrovia a vložené via musí byť spoľahlivá;
Okrem toho musí materiál mať dobrú tepelnú stabilitu, aby odolal nárazom počas zvárania alebo tepelného cyklovania.
Príslušné normy sú IPC-4101B a IPC-4104A, pričom sa týkajú materiálov ako fotosenzitívna kvapalná dielektrická vrstva, suchá filmová dielektrická vrstva, polyimidová fólia, termosetová fólia, rezinou potiahnutý medený plech a štandardný FR-4.
Vo florujúcom globálnom priemysle dosiek HDI obvodov sa Čína stala kľúčovým výrobným centrom a objavilo sa mnoho vysokej kvality výrobcov, z ktorých PCBally je lídrom. So svojím hlbokým know-how a inovatívnou silou spoločnosť PCBally preukázala významné výhody v mnohých oblastiach: